|
REPUBLIQUE ALGERIENNE DEMOCRATIQUE ET
POPULAIRE
MINISTERE DE L'ENSEIGNEMENT SUPERIEUR ET DE LA
RECHERCHE
SCIENTIFIQUE
UNIVERSITE MENTOURI CONSTANTINE
FACULTE DES SIENCES
EXACTES
DEPARTEMENT DE PHYSQIUE
N° d'ordre :
Série :
MEMOIRE PRESENTE POUR OBTENIR
LE DIPLOME DE
MAGISTER
EN SCIENCES DES MATERIAUX
Option : Semiconducteurs
THEME :
Contribution à l'étude structurale et
microstructurale de films
ZnO obtenus par ablation laser
Présenté par :
Adel
TAABOUCHE
Soutenu le 30 /11 /2010
Devant le Jury :
Président : K. MIROUH Prof Université
Mentouri-Constantine
Rapporteur : A. BOUABELLOU Prof Université
Mentouri-Constantine
Examinateurs : S.E. BARAMA Prof Université
Mentouri-Constantine
E. BOUDJEMAA M.C. Université Mentouri-Constantine
Remerciements
Ce fut pour moi un grand honneur
d'avoir la chance de réaliser ce mémoire au sein du Laboratoire
des Couches Minces et Interfaces à l'Université
MentouriConstantine. Ce mémoire m'a permis de rencontrer plusieurs
personnes qui m'ont aidé à accomplir ce travail dans les
meilleures conditions et pour lesquels j'exprime mes remerciements les plus
sincères.
Mes remerciements vont en premier lieu à Allah le
tout Puissant pour la volonté, la santé et la patience qu'il m'a
données durant toutes ces longues années.
Je tiens d'abord à remercier Monsieur A.
BOUABELLOU, professeur à l'Université
Mentouri-Constantine, qui m'a fait l'honneur d'encadrer ce mémoire, m'a
accompagné dans la préparation de ce travail avec une grande
assiduité ainsi qu'avec des qualités humaines remarquables, et
dont la présence au quotidien fut un atout majeur pour la
réalisation de ce travail, tant d'un point de vue scientifique que
moral.
J'adresse mes sincères remerciements à
monsieur K. MIROUH, professeur à l'Université
Mentouri-Constantine de m'avoir fait l'honneur de présider le
jury.
Merci à messieurs S.E. BARAMA et
E. BOUDJEMAA respectivement professeur et maître de
conférences à l'Université Mentouri-Constantine, pour
avoir accepté d'examiner mon travail.
Je remercie tout particulièrement l'inoubliable
défunt R. Halimi, professeur à
l'Université Mentouri -Constantine, que Dieu ait son âme en Son
Vaste Paradis, et qui fut partie de l'accomplissement de ce
mémoire.
Merci à Monsieur T. KERDJA et
toute l'équipe du CDTA (Centre de
Développement des
Techniques Avancées) d'Alger pour la
préparation des échantillons par PLD.
Mes remerciements vont également à Monsieur
C. BENAZZOUZ et tout le groupe du CRNA
(Centre de Recherche
Nucléaire d'Alger) pour la
caractérisation par RBS.
Mes Sincères remerciements vont également
à Messieurs M. BOUAFIA et S. AMARA du
Département d'Optique et de Mécanique de Précésion,
Université de Sétif pour les analyses AFM.
Je remercie en particulier mes collègues Mr
F. Kermiche et Melle S. Menakh qui ont
partagé avec moi tant de moments, heureux ou ardus, et qui m'ont
aidé au cours de cette période de travail.
Mes remerciements également à toute personne
ayant contribué de près ou de loin à la réalisation
de ce travail au niveau du Laboratoire Couches Minces et Interfaces notamment:
Faouzi, Yacine, Charafeddine, Fayssal, Mourad, Djamel, Tarek, Sabrina,
Souheila, Halima, Lamia,...
Enfin, à toute ma famille, petits et grands, pour
leur support, leurs présence ainsi que leur soutien, en particulier mes
parents, ma frangine Amina et mes frangins, un merci
infini.
Table des matières
Introduction générale 1
Chapitre I : Etude bibliographique relative
aux couches minces de ZnO et les techniques de
dépôt
I-1. Propriétés physiques de l'oxyde de zinc 3
I.1.1. Propriétés cristallographiques de ZnO
3
I.1.2. Structure électronique de bande 7
a. Paramètres des caractérisations de la structure
de bande de GaN et de ZnO .. 9
b. Influence des défauts sur la structure de bande
11
I.1.3. Propriétés optiques 12 I.1.4.
Propriétés électriques de ZnO 13
I.2. Applications des couches minces ZnO 15 I.2.1 Application
aux photopiles solaires 15
I.2.2. Applications optoélectroniques .. 17
I.2.3. Optoélectronique dans les
hétérostructures à base de ZnO 17
I.3. Les oxydes transparents et conducteurs (TCO) 17 I.3.1.
Généralités : qu'est-ce qu'un TCO 17 I.3.2. Choix d'un
TCO 21
I.4. Technique expérimentales de dépôt des
couches minces . 22
I.4.1. Dépôts physiques en phase vapeur
22
I.4.1.1. La pulvérisation cathodique 23
I.4.1.2. L'évaporation sous vide .. 25
I.4.1.3. Le dépôt par ablation laser pulsé
(PLD) 26
I.4.1.3.1. Composition du plasma d'ablation Laser 26
I.4.1.3.2. Expansion du plasma d'ablation Laser .. 27
I.4.1.3.3. Le principe du dépôt . 28
I.4.2. Dépôts chimiques en phase vapeur 32
I.4.2.1. Sol-gel . 34
I.4.2.2. Principe général du procédé
spray .. 36
a. Solution de dépôt (source) 36
b. Génération des gouttelettes (transport) 37
c. Réaction chimique sur le substrat (dépôt)
37
Chapitre II: Préparation des films ZnO et
technique de caractérisation
II.1. Choix d'une technique de dépôt en couches
minces 39
II.2. Conditions expérimentales de dépôt
39
II.2.1. Préparation des substrats 39
II.2.2. Préparation des cibles 40
II. 3. Techniques de caractérisation 40
II.3.1.Diffraction des rayons X (DRX) 40
Détermination de la taille des grains et des contraintes
44
II.3.2. Microscopie à force atomique (AFM) .. 46
II.3.3. Analyse RBS . 48
a. Principe de la spectroscopie RBS 48
b. Conditions expérimentales .. 52
II.3.4. Caractérisation optique . 52
Chapitre III: Résultats et discussions
III.1. Analyse par RBS 58
III.2. Analyse par diffraction des rayons X 61
III.2.1. Effet du dopage .. 61
III.2.1.1. Substrat de verre .. 61
III.2.1.2. Substrat de silicium Si(100) 64
III.2.1.3. Substrat de silicium Si(111) 68
III.2.1.4. Substrat de silicium polycristallin (Si-poly) 71
III.3. Analyse par AFM .. 78
III.3.1. Effet de dopage .. 78
III.3.2. Effet des substrats .. 84
III.4. Propriété optique . 86
Conclusion Générale .. 89
Références bibliographiques .. 91
Introduction générale
Introduction générale
L'oxyde de zinc est un composé semi conducteur
transparent de type II-VI avec une conductivité naturelle de type n. Les
propriétés notables de ZnO son sa largeur directe (3.27 eV)
à température ambiante et son énergie de liaison d'exciton
élevée (60 meV) qui est très supérieure à
celle de certains matériaux couramment utilisés tel que ZnSe (20
meV) et GaN (25 meV). La non-toxicité et l'abondance de ZnO sur la terre
font de lui un candidat idéal utilisé comme contact
électrique transparent pour les cellules solaires en couches minces. Ce
matériau est d'une grande importance dans le domaine de
l'optoélectronique et de la photovoltaïque. Il peut être
utilisé dans plusieurs applications dans différents domaines
scientifiques et industriels tels que les transducteurs
piézoélectriques, les guides d'onde, détecteurs à
gaz, électrodes transparentes conductrices, varistors.
Parmi les nombreuses techniques d'élaboration de
matériaux micro- ou nanostructurés, on peut citer
l'élaboration par voie chimique CVD (Chemical Vapor Deposition).
Cependant, ces techniques ont l'inconvénient de conduire à des
films contaminés par les résidus des précurseurs et
d'avoir une température de réaction souvent élevée.
On peut aussi citer l'élaboration par voie physique PVD (Physical Vapor
Deposition) qui regroupe principalement l'évaporation, la
pulvérisation sous toutes ses formes et l'ablation laser. Les
dépôts PVD présentent beaucoup d'avantages par rapport aux
dépôts CVD. Les techniques PVD permettent de fabriquer des films
denses et de ne pas avoir de pollution (contamination).
Les échantillons relatifs à cette étude
sont préparés par ablation laser pulsé de l'oxyde non
dopé (ZnO) et dopé en aluminium (AZO). La technique PLD est un
procédé de laboratoire qui permet le dépôt d'une
multitude de composés de haute pureté allant des supraconducteurs
à haute température critiques aux matériaux durs. La
pureté des dépôts ne dépend dans ce cas que de la
pureté de la cible utilisée. La technique PLD présente
également l'avantage d'une grande souplesse d'utilisation aussi bien
pour le dépôt en couche mince que pour la réalisation de
nanostructures.
L'ablation laser apparaît donc comme la méthode
de qui s'adapte le mieux pour la croissance de tels oxydes en couches minces ou
sous forme de nanostructures avec une composition et une stoechiométrie
contrôlée, et une structure cristalline de qualité. Les
propriétés structurale, optique et électronique de tels
films d'oxydes étant fortement dépendantes de la nature et de la
concentration des défauts de structure présents dans ces
couches.
Il s'agit d'étudier la croissance par ablation laser de
l'oxyde de Zinc non dopé et dopé à
l'aluminium en films
minces, en fonction des conditions expérimentales (le type des
substrats
et le taux de dopage), et de corréler leurs
propriétés optiques (valeur du gap, transmittance) avec leurs
caractéristiques morphologiques.
Dans le premier chapitre, nous commençons par une
étude bibliographique générale et une description du
matériau étudié dans son aspect fondamental. Aussi, une
attention particulière est portée sur les applications des oxydes
transparents conducteurs (TCO).
Le deuxième chapitre décrit d'une part les
différentes étapes expérimentales suivies pour
préparer les échantillons ZnO et AZO. D'autre part les techniques
expérimentales mises en oeuvre y l'élaboration de ce travail de
thèse. En premier lieu, nous détaillons les conditions de
dépôts de sont décrites.
Dans le troisième et dernier chapitre, nous
présentons les résultats d'analyse la composition et
détermination de l'épaisseur par RBS et étude des
propriétés structurales, morphologiques et optiques des
échantillons élaborées. L'évolution de ces
propriétés physiques en fonction du dopage et du type des
substrats utilisés y est étudiée et analysée.
Enfin, nous terminons ce manuscrit par une conclusion
générale sur les résultats d'analyse expérimentale
obtenus.
Chapitre I
Etude bibliographique relative aux
couches minces de ZnO et les
techniques de dépôt
I-1. Propriétés physiques de l'oxyde de
zinc
Les principales propriétés physiques de l'oxyde de
zinc de structure hexagonale [1] sont regroupées dans le tableau 1.
Tableau 1 :
Propriétés physiques de l'oxyde de zinc à structure
hexagonale.
|
Propriété
|
Valeur
|
|
Paramètres de maille à 300 K :
a
0
c
0
c/a
00
|
0,32495 nm
0,52069 nm
1,602 (1,633 pour la structure
hexagonale
idéale)
|
|
Masse volumique
|
5,606 g cm-3
|
|
Phase stable à 300 K
|
wurtzite
|
|
Point de fusion
|
1975°C
|
|
Conductivité thermique
|
1-1,2 W m-1 K-1
|
|
Coefficient d'expansion linéaire (/°C)
|
-6-6
a: 6,5 10, c: 3,0 10
0 0
|
|
Permittivité relative
|
8,656
|
|
Indice de réfraction
|
2,008-2,029
|
|
Energie de la bande interdite (gap)
|
3,4 eV (direct)
|
|
Concentration de porteurs intrinsèques
|
< 106 cm-3
|
|
Energie de liaison des excitons
|
60 meV
|
|
Masse effective de l'électron
|
0,24
|
|
Mobilité Hall de l'électron à 300 K pour
une
conductivité de type n faible
|
2 -1 -1
200 cmVs
|
|
Masse effective du trou
|
0,59
|
|
Mobilité Hall du trou à 300 K pour une
conductivité
de type p faible
|
2 -1 -1
5 - 50 cmVs
|
I.1.1. Propriétés cristallographiques de
ZnO
Les semi-conducteurs II-VI cristallisent dans la structure
zinc blende ou wurtzite. Ces deux types de structure sont formés de
l'empilement de plans d'anions et de cations successifs de maille hexagonale.
Cette structure permet des liaisons sp3 de symétrie
tétraédrique caractéristiques des liaisons covalentes des
semi-conducteurs. Les semi-conducteurs II-VI sont formés d'anions
A2-(A=O, S, Se, Te) et de cations B2+ (B=Zn, Cd,
Hg). Les composés ZnA et CdA sont semi-conducteurs. On limitera
l'étude aux composés à base de ZnO.
On connaît actuellement trois phases cristallographiques
différentes pour l'oxyde de zinc (figure I.1) : la phase B4 (Wurtzite),
la phase B3 (Blende) et la phase B1 (Rocksalt). La structure Wurtzite
(hexagonale) est la structure thermodynamiquement stable à
température ambiante. La structure Blende (cubique) est observée
lorsque ZnO est déposé sur certains substrats de symétrie
cubique, La structure Rocksalt (NaCl) est obtenue lorsqu'une pression
hydrostatique (10-15 GPa) est appliquée sur la structure Wurtzite. Cette
dernière est une phase métastable qui peut persister à
pression atmosphérique.

Figure I.1 : Représentation des structures
de ZnO : (a) cubique rocksalt, (b) cubique zinc blende et
(c) hexagonal
wurtzite.
La phase wurtzite (WZ) se distingue de la phase blende de
zinc(ZB) seulement par la séquence d'empilement des couches d'atomes.
Les plans hexagonaux s'empilent suivant la séquence ABCABC selon [111]
en phase ZB (figure I.2(c)) et suivant la séquence ABAB selon [0001] en
phase WZ (figure I.2(d)).
La structure blende de zinc appartient au groupe d'espace F43m
(Td) et correspond à deux sous-réseaux cubiques à face
centrées formées respectivement des atomes de la colonne III et V
décalés l'un de l'autre du quart d'une diagonale du cube. Le
paramètre de maille a correspond à la longueur d'une arête
du cube.
La structure wurtzite appartient au groupe d'espace P63mc
(C46v) et correspond à deux sousréseaux
hexagonaux compacts composés d'atomes de chacune des deux colonnes
(III-V ou II-VI) décalés de 3/8c, c et a étant les
paramètres de maille (figure I.2(b)). Ils forment un empilement de type
ABAB selon l'axe [0001] aussi appelé axe c de la structure wurtzite.
Dans cette thèse nous nous intéresserons uniquement à la
structure de type Wurtzite.
Le tableau (2) illustre la différence entre ces deux
structures.
Tableau 2: Comparaison entre les
propriétés des deux structures de ZnO.
|
Structure wurtzite
|
Structure cubique
|
|
Paramètre de réseau (A)
|
a=3.24
c=5.20
|
a=4.28
|
|
Coordination (Z)
|
2
|
4
|
|
Densité (g/cm3)
|
5.6
|
6.9
|
|
Groupe spatial
|
P63mc
|
Fm3m
|
|
Condition d'apparition (kbar)
|
Pression atmosphérique
|
Haute pression p=100
|

Figure I.2 : Représentation
schématique de la structure cristaiographique (a) blende de zinc et
(b)
wurtzite. Les séquences d'empilement de couches atomiques sont
mises en évidence en (c) et (d) :
ABCABC en blende de zinc et ABAB en
wurtzite.
L'oxyde de zinc cristallise dans les conditions normales suivant
une structure de type wurtzite, donnée par la figure I.2.b.
La maille hexagonale de la structure Wurtzite se
caractérise par trois constantes de réseau a, c et u ; a
étant le côté d'un losange constituant la base, c le
côté parallèle à l'axe oz et u est une
coordonnée intérieure le long de cet axe. Ces constantes
déterminent la position relative des sous-réseaux de l'anion
O2 et du cation Zn2+. La
coordonnée u est définie par la relation suivante :
2
1 c
2
u = +
4 3a
D'après cette relation, on remarque que le
paramètre u est sans dimension. La distance séparant les plans
réticulaires d'indices (h,k,l) est donnée par la relation :
1 4 2 2
= 2 ( h hk k
+ + )
dhkl a
2 3
l 2
+
c 2
La condition de stabilité de cette structure est
donnée par la relation suivante :
R
0,225 = a =0,4 1 4
Rc
où Ra et Rc
désignent respectivement le rayon de l'anion et celui du cation.
L'origine de cette condition provient des considérations suivantes :
¾ pour une structure hexagonale compacte (H.C.), on a :
3
R a R c 8 c
+ =
Avec

c
=
a
2
3
2
Et
2Ra < a
¾ Comme la structure H.C dérive de la structure
cubique à face centré (C.F.C.) de la
blende, on a aussi

Dans le tableau 3, on présente un récapitulatif
des caractéristiques importantes de l'oxyde de zinc. D'après les
valeurs des rayons ioniques du cation et de l'anion indiquées dans le
tableau, on peut remarquer que la structure est relativement ouverte. En effet,
les atomes de zinc et d'oxygène n'occupent que 40 % du volume du cristal
[2], laissant des espaces vides de rayon 0,95 Å. Il est possible que,
dans certaines conditions, des atomes de zinc en excès
puissent se loger dans ces espaces c'est-à-dire en
position interstitielle. Cette caractéristique permet d'expliquer
certaines propriétés particulières de l'oxyde,
liées aux phénomènes de semi-conductivité, de
photoconductivité, de luminescence, ainsi qu'aux
propriétés catalytiques et chimiques du solide [3].
Tableau. 3 : Récapitulatif des
caractéristiques de la structure cristalline du ZnO
|
Réseau
|
Hexagonal Wurtzite
|
|
Paramètres de maille
|
a =
|
3,2499 A = 1,6019 5,2060 A
|
|
c/a
|
|
c =
|
|
Distance entre O2- et
Zn2+, (les plus proches
voisins)
|
Suivant l'axe c d = 1,96 A
Pour les trois autres d = 1,98 A
|
|
Rayon ionique pour
une
coordination
tétraédrique
|
Liaison covalente
Liaison ionique
|
Zn neutre = 1,31 A
Zn2+ = 0,60
A
Zn2+ : 0,70 A
Zn2+ : 0,78 A
Zn2+ :
0,60 A
|
O neutre = 0,66 A
O2- = 1,38
A
O2- : 1,32 A (Pauling) [4]
O2- : 1,24 A
(Goldsmith)[5]
O2- : 1,38 A (Shannon) [6]
|
|
Rayon cristallin pour une
coordination
tétraédrique
|
Zn2+= 0,74 A
O2 = 1,24
A
|
I.1.2. Structure électronique de bande
Dans un matériau semiconducteur, les porteurs sont
libres de se mouvoir selon les trois directions de l'espace. Les états
d'énergie qui leur sont accessibles sont répartis selon des
bandes d'énergie dont la structure exacte est déterminée
par le potentiel cristallin et ses symétries. La description des
propriétés optiques de semiconducteurs à gap direct ne
nécessite généralement que la connaissance des
états électroniques au voisinage du centre de la zone de
Brillouin, au point .
Nous allons donc décrire ici les structures de bandes
des semiconducteurs de chacune des deux phases ZB et WZ qui différent en
raison des différences entre leurs structures cristallographiques.

Figure. 1.3 : Représentation
schématique de la structure de bandes d'un semiconducteur
de
structure cristaiographique de type (a) blende de zinc (exemple pour GaN,
d'après [7]) et (b)
wurtzite, d'après [8] (exemple pour ZnO,
d'après [9]).
Plus de détails sur la structure de bandes peuvent
être trouvés dans la référence [10] et les
références incluses.
Dans le cas de la structure wurtzite (groupe ponctuel
C6v), l'abaissement de la symétrie du cristal entraîne
une levée de dégénérescence partielle de la bande
de valence par l'interaction avec le champ cristallin. L'écart entre les
bandes de valence est alors donné par l'énergie ÄCR.
L'interaction spin-orbite conduit ensuite à lever la
dégénérescence de la bande de valence de plus haute
énergie donnant ainsi lieu à trois bandes de valence non
dégénérées, appelées bandes A, B et C (voir
Figure. I.3(b)).
Dans ZnO, la nature exacte des états de valence A et B
en terme d'ordre des états de symétrie 7 ou 9 a fait l'objet d'un
débat très animé [11-13]. Les calculs théoriques et
les
mesures expérimentales ont du mal à trancher
dans la mesure où ÄSO < ÄCR tandis que pour les autres
semiconducteurs II-VI, l'énergie de couplage spin-orbite est toujours
plus grande que l'énergie du couplage avec le champ cristallin [14].
Nous verrons par la suite que nos expériences sont insensibles à
cet ordre des bandes de valence A et B.
a. Paramètres caractéristiques de la
structure de bandes de GaN et de ZnO ; la valeur des énergies
de bande interdite, de spin-orbite et de champ cristallin pour les
semiconducteurs auxquels nous allons nous intéresser sont donnés
dans le tableau 4. La Figure I.4 permet de comparer les valeurs des
énergies de bande interdite de GaN et de ZnO par rapport à celles
de plusieurs autres familles de semiconducteurs III-V et II-VI.
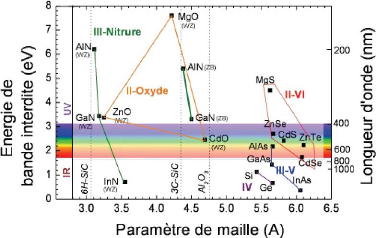
Figure1.4 : Energie de bande interdite en fonction
du paramètre de maille pour plusieurs familles
de semiconducteurs,
[13, 15-17].
Tableau. 4 : Paramètres
caractéristiques de la structure de bandes de GaN, AlN et ZnO
(d'après [13, 18, 19, 11])
|
Phase
|
GaN
|
AlN
|
ZnO
|
|
Eg (eV)
|
WZ
|
3.39
|
6.28
|
3.37
|
|
à 300 K
|
ZB
|
: 3.299
|
: 5.4
|
: 3.27
|
|
|
X : 4.52
|
X : 4.9
|
-
|
|
|
|
(gap indirect)
|
|
|
ÄSO (meV)
|
WZ
|
17
|
19
|
8-16
|
|
ZB
|
17
|
19
|
-
|
|
ÄCR (meV)
|
WZ
|
10
|
-169
|
39-42
|
On rappelle que les structures électroniques de bande de
l'oxygène et du zinc sont : O :
1s22s22p4
Zn :
1s22s22p63s23p63d104s2
Les états 2p de l'oxygène forment la bande de
valence et les états 4s du zinc constituent la zone de conduction du
semi-conducteur du ZnO.
La figure I.5 illustre l'allure de la structure de bande du
ZnO. Il existe en réalité six bandes résultantes des
états 2p de l'oxygène, et les plus bas des bandes de conduction
ont une forte contribution des états 4s du Zinc.
La structure électronique de bandes montre que le ZnO
est un semi-conducteur à gap direct, le minimum de la bande de
conduction et le maximum de la bande de valence sont situés au point .
La largeur de la bande interdite est de l'ordre de 3,2 eV.

Figure I.5. Structure de bande de ZnO en utilisant
le pseudo-potentiel de O6+ (la référence
zéro
correspond au maximum d'énergie de la bande de
valence
b. Influence des défauts sur la structure de
bandes
Les solides cristallins ne sont jamais parfaits, et il existe
toujours des défauts qui affectent les diagrammes de bandes des solides.
Par exemple, pour le cristal de ZnO, les défauts dans le réseau
cristallin peuvent se présenter sous forme d'atomes manquants ou
d'atomes en position interstitielle, mais également sous forme
d'impuretés métalliques.
Ces défauts induisent alors des niveaux
d'énergie discrets dans le diagramme électronique de ces
matériaux comme le montre la Figure I.6. Les conditions
d'élaboration sont responsables de la création des
défauts.


Figure I.6. Schéma de bandes pour
ZnO.
I.1.3. Propriétés optiques.
L'interaction de la lumière (onde
électromagnétique) avec la matière (électrons du
matériau) peut expliquer les propriétés optiques d'un
matériau.
Lors de l'application de la théorie de dispersion sur
un matériau, il convient de séparer l'absorption fondamentale de
l'absorption des porteurs libres. Si seule la première contribution est
présente, le matériau est qualifié de diélectrique.
Le cas échéant, le matériau est un métal. Pour les
semi-conducteurs, les deux contributions sont importantes. La première
correspond au seuil d'absorption interbandes et sépare la zone
d'absorption dans l'ultraviolet de la zone à forte transparence dans le
visible. La seconde repère le front de la montée de la
réflectivité dans l'infrarouge correspondant aux oscillations de
plasma des électrons de conduction.
Une onde électromagnétique interagissant avec le
semi-conducteur sera complètement absorbée par celui-ci si
l'énergie associé à l'onde électromagnétique
est capable de transférer des électrons de la bande de valence
à la bande de conduction, c'est-à-dire, si cette énergie
est au moins égale à celle de la largeur de la bande
interdite.
L'indice de réfraction (n) est un paramètre
physique important caractéristique des matériaux. La structure du
cristal de ZnO est de type hexagonal compact, ce qui conduit à une
anisotropie des propriétés physiques. Dans le cas de l'indice de
réfraction, on obtient deux indices différents selon
l'orientation du cristal, l'un noté no (polarisation E // à l'axe
c du cristal) et
l'autre noté ne (polarisation E - à l'axe c
du cristal). La figure I.7 montre la dispersion des indices de
réfraction ne et n0 en fonction de la longueur d'onde
[20].
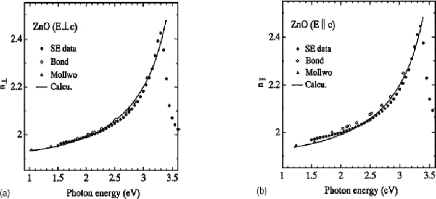
Figure I.7. Courbe de dispersion des indices de
réfraction ne (a) et no(b) dans ZnO
[20].
L'indice de réfraction de l'oxyde de zinc sous la forme
massive est égal à 2,0 [21]. En couches minces, son indice de
réfraction et son coefficient d'absorption varient en fonction des
conditions d'élaboration des couches. L'indice de réfraction a
une valeur variant entre 1,7 et 2,2 [22, 23]. L'amélioration de la
steochiométrie de ZnO conduit à une diminution du coefficient
d'absorption et à une augmentation de l'énergie de la bande
interdite [24, 25]. L'oxyde de zinc dopé entre dans la classe des oxydes
transparents conducteurs dits TCO. Très peu dopé, il peut
être utilisé en luminescence [26].
Sous l'effet d'un champ électromagnétique
intense, d'une énergie supérieure à l'énergie de la
bande interdite (dans notre cas supérieure à 3,37 eV),
l'oxyde de zinc émet des photons, c'est ce qu'on appelle la
photoluminescence. En pratique, différentes émissions (bandes de
luminescence) peuvent être observées en fonction des
méthodes d'élaboration et de traitement. Dans les couches minces
de ZnO, la luminescence visible est due aux défauts liés aux
émissions des niveaux profonds (niveaux virtuels entre la bande de
conduction et la bande de valence), tels que les interstitiels de zinc et les
lacunes d'oxygène [27].
I.1.4. Propriétés électriques de
ZnO
ZnO possède des propriétés
piézoélectriques dues à sa symétrie axiale [28].
C'est également un semi-conducteur II-VI intrinsèquement de type
n. Le type p est très difficile à obtenir. Récemment il a
été préparé, à partir de méthodes
physiques [29] mais il n'a jamais été synthétisé
à partir d'une méthode en solution. C'est un semi-conducteur
dégénéré de type
n, La grande conductivité des couches d'oxydes ZnO purs
est due à la forte concentration en porteurs (électrons),
étant donné que la mobilité dans ces couches est
considérablement plus faible que celle en volume du matériau
correspondant. La forte concentration en électrons est attribuée
à la déviation par rapport à la stoechiométrie (ou
défauts dans la structure).
Il y a une certaine anomalie dans la littérature
concernant l'énergie du gap. Srikant et Clarke [30] suggèrent que
le gap d'énergie de ZnO à la température ambiante est de
3,3 eV, tandis qu'une bande de valence à la transition de
niveau de donneur à 3,15 eV explique le fait qu'une valeur
faible plus (typiquement 3,2 eV) est souvent rapportée.
Ainsi, le gap de ZnO à température ambiante est
compris entre 3,2 et 3,3 eV.
Une conductivité élevée (> 5.103
?-1.cm-1) est possible dans ZnO de
type n en raison des défauts intrinsèques, des dopants (Al, In,
Ga, B, F, autres) ou en combinaison [31].
Les mobilités des électrons dans des couches
minces de ZnO rapportées, sont typiquement de l'ordre de 20 à 30
cm2/V.s. En outre, la mobilité maximale
obtenue dans les cristaux simples de ZnO est de l'ordre de 200
cm2/V.s.
La réaction de formation de ZnO (stoechiométrique)
est la suivante :

La conductivité de type p a été
découverte pour la première fois par Aoki et al. en 2001 [32]. Il
est possible de modifier largement les propriétés d'oxyde de zinc
par dopage :
- soit en s'écartant de la stoechiométrie ZnO,
principalement par l'introduction d'atomes de zinc en excès en position
interstitielle, ou par la création de lacunes d'oxygène (les
centres créés se comportent alors comme des donneurs
d'électrons) [33] ;
- soit en substituant des atomes de zinc ou d'oxygène
du réseau par des atomes étrangers de valence différente
(élément du groupe III, F-, Cl-).
Il est intéressant de noter ici que le dopage de ZnO
avec l'aluminium fait diminuer la concentration de Zn en position
interstitielle, réduisant de ce fait la rapidité d'oxydation du
Zn [34]. Ce phénomène peut revêtir une grande importance
puisque cela réduirait considérablement l'adsorption
d'oxygène qui a été une des causes principales de
limitation de l'utilisation de ZnO comme conducteur transparent.
En pratique, on obtient uniquement par dopage une semi
conductivité de type n. Les taux de dopage obtenus peuvent être
très élevés (de l'ordre de 1020
atomes/cm3), permettant d'atteindre des résistivités
très faibles (de l'ordre de 10-4 ?. cm) [35].
De nombreuses études ont montré qu'un traitement
thermique adéquat après la croissance des cristaux de ZnO (recuit
à haute température) peut changer considérablement les
propriétés électriques des cristaux, Par exemple il a
été remarqué que pour des cristaux de ZnO
présentant une haute résistivité et avec une grande
concentration des porteurs de charge [36- 38], un traitement sous air ou sous
oxygène donne un effet opposé pour des cristaux de faible
résistivité [39,40].
I.2. Applications des couches minces ZnO
L'oxyde de zinc présente un ensemble de
propriétés physiques susceptibles d'aboutir à de
nombreuses applications dans le domaine de l'électronique, la
photovoltaïque et de l'optoélectronique.
I.2.1. Application aux photopiles solaires
Les progrès réalisés durant ces
dernières années dans la filière des photopiles solaires
en couches minces à base de ZnO sont remarquables.
La structure de base d'une cellule solaire est donnée par
la figure I. 8.
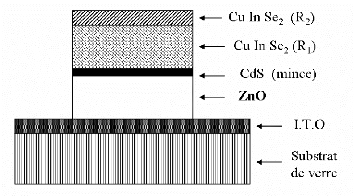
Figure I.8 : Vue en coupe d'une photopile
solaire
Elle est composée d'un empilement de couches
déposées suivant l'ordre suivant:
· Une électrode transparente et conductrice
d'I.T.O. (oxyde d'indium dopé à l'étain) est
déposée sur un substrat de verre utilisée comme contact
arrière.
· Ensuite une couche d'oxyde de zinc non dopée ou
dopée à l'aluminium ou à l'indium est
déposée sur la couche d'I.T.O.
Pour former la jonction, on dépose le composé
CuInSe2 en deux étapes :
> Une première couche R1 (de grande
résistivité ñ = 10 Ù.cm ; d'épaisseur e = 1
à 1,5 um) formant l'hétérojonction avec la couche mince de
CdS.
> Une deuxième couche R2 de faibles
résistivité et épaisseur (ñ = 10 Ù.cm ; e =
0,8 à 1 um) permettant la prise de contact.
Par rapport à la photopile type CdS/CuInSe2,
l'introduction du ZnO permet un élargissement de la fenêtre de
capture. Ceci va permettre un accroissement du courant de court-circuit.
L'augmentation du photocourant provient du fait que :
_ ZnO transmet des photons dont les longueurs d'onde sont
comprises entre 380 nm et 520 nm jusqu'au CuInSe2 alors que normalement ils
sont absorbés dans CdS mince.
_ ZnO réduit les pertes par réflexion
au-delà du spectre visible. Plusieurs facteurs limitent le photocourant
comme :
_ les réflexions optiques,
_ l'absorption optique non désirée dans la couche
frontale,
_ l'absorption optique incomplète dans la couche
absorbante, _ la collecte incomplète des porteurs minoritaires.
Pour y remédier, il faudrait :
_ améliorer la structure et la conductivité de la
couche frontale transparente de ZnO afin de réduire les pertes par
réflexions et par absorption plasma,
_ réduire l'épaisseur de la couche absorbante
CuInSe2,
_ utiliser un réflecteur arrière qui susciterait
l'absorption de photons dans la région active du composant,
_ augmenter la durée de vie des porteurs minoritaires
et/ou utiliser des miroirs (par exemple BSF : champ de surface arrière)
pour les porteurs minoritaires, ce qui devrait augmenter la réponse vers
les grandes longueurs d'onde.
I.2.2. Applications optoélectroniques
Depuis plusieurs années, un effort de recherche
important a été développé dans les domaines des
applications pratiques des semiconducteurs à large bande interdite tels
que ZnO en optoélectronique.
En effet, les principaux objectifs sont la réalisation
de détecteurs ultraviolets (UV) et la fabrication de diodes laser
émettant dans le bleu ou l'UV. Cependant, l'enjeu du
développement des émetteurs bleus est considérable puisque
l'émission bleue est le dernier élément nécessaire
à la reconstitution de la lumière blanche. Les films de ZnO
peuvent alors trouver des applications dans les affiches couleurs sur
écrans plats. D'autre part, le développement de lasers bleus et
UV permet de réduire la longueur d'onde du faisceau émis et donc
le stockage de données en grande densité.
I.2.3. Optoélectronique dans les
hétérostructures à base de ZnO
Le formidable essor des filières industrielles
basées sur le développement de la micro- électronique et
de l'optoélectronique repose sur une seule propriété de
l'électron : sa charge électrique. L'autre caractéristique
de l'électron, son spin, est utilisée pour le stockage
d'information par des matériaux magnétiques, mais elle a
été jusqu'à présent complètement
ignorée dans les semi-conducteurs.
Un effort important de recherche se développe
actuellement afin d'utiliser simultanément la charge et le spin de
l'électron. L'objectif est de réaliser l'intégration
simultanée des capacités de stockage et de traitement de
l'information, mais aussi d'exploiter, à terme, la nature quantique de
l'état de spin devant conduire à l'ordinateur quantique. Les
matériaux semiconducteurs magnétiques sont
particulièrement bien adaptés pour cette application.
Les prédictions théoriques les plus
récentes montrent que des alliages semi-magnétiques à base
de ZnO pourraient être ferromagnétiques à
température ambiante, ce qui ouvrirait ainsi la voie extrêmement
prometteuse de l'injection de courants de spin polarisés dans des
hétérostructures semi-conductrices nonmagnétiques.
I.3. Les oxydes transparents et conducteurs (TCO)
I.3.1. Généralités : qu'est-ce qu'un
TCO
Selon la théorie des bandes d'énergie, trois
états électriques sont possibles : métal, isolant et
semi-conducteur. Dans le métal, la bande de conduction (BC) et la bande
de valence (BV) se recouvrent, permettant la libre circulation des
électrons. Le semi-conducteur, quant à lui, a une bande interdite
qui sépare BV et BC communément appelée gap et
notée Eg. Les
électrons ne peuvent pas prendre les énergies
situées dans cette bande. Il faut qu'ils acquièrent de
l'énergie pour passer dans BC. Pour un gap supérieur à 4
eV, on parle d'isolant car même à température ambiante, BC
est vide.
Un matériau, avec une transparence dans le visible et
des propriétés de conduction, a des propriétés
antinomiques d'un point de vue physique. En fait, les matériaux
conducteurs tels que les métaux
réfléchissent une grande partie du spectre
électromagnétique dans la partie du visible grâce à
leurs électrons libres. Les verres sont des matériaux communs
transparents dans le visible. Un verre est un
matériau amorphe, i.e. sa structure n'est pas
cristallisée. Ce matériau a une valeur de gap très
élevée et ne peut conduire un courant électrique. Il est
alors dit isolant. A première vue, l'association des
deux propriétés est incompatible.
Cependant, les semi-conducteurs possédant un large gap
sont théoriquement transparents dans le domaine du visible. Le
dépôt en couche mince de ce type de matériau assure une
faible absorption. Grâce au dopage du matériau, soit un apport
d'impuretés qui augmente le nombre d'électrons libres, la
conduction est accrue pour en faire un « mauvais métal ».
Les oxydes métalliques sont en général
des semi-conducteurs à large gap. Ils peuvent être
symbolisés par MO avec M un atome de métal et O un atome
d'oxygène. La méthode CLOA (Méthode de Combinaison
Linéaire des Orbitales Atomiques) permet de donner une vision simple de
la structure de bandes d'un tel matériau. La combinaison des orbitales
2p de O et nd de M (n étant le nombre quantique principal, n > 2 pour
avoir des couches d dans notre exemple) forment les liaisons ðp liantes et
ðp* antiliantes. L'orbitale 2p de O est prédominante et
contribue principalement à ðp formant le haut de la bande de valence
(BC).
De même la combinaison des orbitales s, l'orbitale 2s
pour l'oxygène et ns pour M, forment les orbitales óS liantes et
óS* antiliantes. L'orbitale ns de M sera prédominante
et contribuera principalement à la formation de óS*
créant le bas de la bande de conduction (BC). Un exemple de cette
application est donné dans la figure I.9 pour la formation de ZnO
où l'écart
|
entre óS *
|
et ðp forme le gap Eg.
|
Pour résumer, une vision simple consiste à voir
la bande de valence essentiellement composée des orbitales 2p de O et la
bande de conduction essentiellement composée de l'orbitale ns de M. La
propagation des électrons est donc faite le long des orbitales ns de
M.
Cette notion a été utilisée pour
illustrer la possibilité de grande mobilité dans ces mêmes
matériaux mais sous forme amorphe. H. Hosono a démontré la
possibilité d'une forte mobilité dans les TCO amorphes [11]. Le
semi-conducteur transparent 2.CdO.GeO2 sous forme amorphe présente une
grande mobilité d'environ 10
cm2.V-1.S-1, comparé à un
matériau amorphe plus commun a-Si:H ayant une mobilité de 1
cm2.V-1.S-1.
Grâce à cette découverte le
dépôt de TCO à basse température sans
cristallisation est possible. L'équipe de Martins et Fortunado a ainsi
déposé des films TCO amorphes sur substrat de papier et
créé des transistors à base de matériaux
transparents et conducteurs [41].
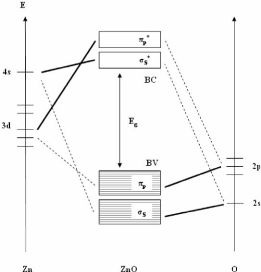
Figure I.9. Diagramme simplifié de la
structure de bandes du ZnO.
Selon le niveau des orbitales et les différentes
interactions possibles, certains oxydes métalliques ne sont pas des
semi-conducteurs à grand gap. Par exemple, pour les oxydes
composés des éléments de la colonne IV, l'oxyde de
silicium SiO2 est isolant comme d'ailleurs l'oxyde de germanium GeO2. L'oxyde
d'étain SnO2 est un semi-conducteur et l'oxyde de plomb PbO2 a un
comportement métallique.
Il existe un grand nombre d'oxydes métalliques
possédant tous leurs propres propriétés. Ainsi, l'oxyde de
vanadium possède une transition métal - semi-conducteur
dépendant de la température. A une température de
68°C, le matériau change de structure et son comportement passe de
semi-conducteur à métallique [42]. L'oxyde de titane, quant
à lui, a une surface photocatalytique réagissant au rayonnent UV
[43]. Une application possible est la
création d'une surface propre qui tue toute
bactérie à son contact sous illumination UV. De nombreuses
recherches actuelles tentent, grâce à des dopants tels que le bore
ou le vanadium, de ramener son activité photocatalytique dans le domaine
du visible [44, 45].
De nombreux autres matériaux sont étudiés
tels que des oxydes ternaires Cd2SnO4, Zn2SnO4, MgIn2O4 et GaInO3 [46]
présentant des structures particulières telles que la structure
delafossite [47].
Afin d'illustrer les différents
phénomènes mis en jeu au sein de tous ces matériaux,
les notations de Kröger et Vink ont été
utilisées dans ce manuscrit. Ces conventions décrivent
les charges électriques et les positions de défauts
présentes dans le réseau d'un cristal. La
notation d'un élément M avec une charge C dans un site S
se note : Le M représente
l'élément mis en jeu mais peut être aussi
une vacance notée V, un électron ou un trou. Le C
représente la charge avec M' pour une charge négative,
M
· pour une charge positive et Mx
pour une charge neutre. Le S représente l'emplacement de
l'élément, par exemple i, pour une position
interstitielle. Les défauts intrinsèques et extrinsèques
peuvent être écrits grâce à cette
notation comme la capture d'un électron libre par une lacune de
zinc :

Avant de décrire en détail les
propriétés optiques et électriques des TCO, des solutions
alternatives à l'utilisation de ces matériaux sont possibles. Des
films de métaux extrêmement fins inférieurs à 10 nm,
peuvent jouer le rôle de matériaux transparents et conducteurs. En
effet, des couches d'or, d'argent ou de cuivre peuvent être
utilisées à cet effet. De même, des fines couches de chrome
et de nickel égalisent les performances de l'ITO comme le montrent Ghosh
et al. dans leurs travaux [48]. Dans le cas de cellules solaires
organiques, des recherches sont également poursuivies pour trouver un
remplaçant organique, conducteur et transparent [49].
Dopage n
Afin d'améliorer la conductivité des
matériaux, le nombre de porteurs de charges est augmenté par le
dopage. Selon le matériau ou le type de dopant, le dopage peut
être de substitution, de vacances ou d'implantations interstitielles.
Dépendant de la valence des dopants, accepteurs ou donneurs, le dopage
induira une conductivité de type n ou p.
Le dopage par substitution peut se faire sur le cation (le
métal) ou l'anion (l'oxygène).
Des paramètres tels que la solubilité solide du
dopant dans le réseau du matériau hôte ou la
taille du
dopant, influenceront également la possibilité d'un dopage. Il
existe de nombreux
dopages par substitution du cation. L'oxyde d'indium peut
être dopé par du molybdène [50] pour améliorer ses
caractéristiques ou bien par des éléments comme le titane
[51]. Cependant, énormément de travaux se tournent vers la
recherche et la compréhension du dopage qui a donné les meilleurs
résultats. Notons ainsi le dopage à l'étain donnant
l'oxyde d'indium dopé étain : ITO [52]. La littérature
relate peu de travaux concernant des études de dopage autre qu'avec
l'étain. Le dopage de l'oxyde de zinc ZnO est possible avec de nombreux
éléments tels que Al [53], Ga [54], In [55] et autre. Il en est
de même pour l'oxyde SnO2 avec des éléments tels que Sb
[56], Nb, Ta [57], ou des métaux de transitions Cu, Fe, Co et Ni
[58].
La liste des éléments n'est pas exhaustive et
ils existent de nombreux travaux sur beaucoup de sortes de dopage. Des exemples
d'étude sur le co-dopage se trouvent dans la littérature comme
par exemple le co-dopage Al-Ti du ZnO [59].
Les dopages par substitution de l'anion oxygène sont
plus rares. Or, le dopage au fluor est l'un des meilleurs dopants pour SnO2
[60]. Pour ZnO, des recherches sont menées sur des dopages au fluor mais
aussi au bore [61] ou encore au lithium [62].
Tous les dopages évoqués ci-dessus renforcent le
type n des TCO semi-conducteurs.
En effet, un niveau de dopant est créé sous BC
et l'augmentation de dopage développe une bande d'énergie
chevauchant la bande de conduction. Ainsi, un grand nombre d'électrons
participent à la conduction, d'où l'augmentation de la conduction
par dopage.
Dopage p
Le dopage de type p reste, quant à lui, encore
controversé. Comme vu précédemment, les TCO tels que le
SnO2 ou le ZnO sont intrinsèquement de type n. Un calcul
théorique réalisé par Zhang et al. confirme cette
tendance [63]. Néanmoins, depuis quelques années, de plus en plus
de travaux expérimentaux portent sur les couches minces de TCO de type p
grâce à différents dopages : ZnO:N [64], ZnO:Al-N [65],
SnO2:Sb [66]. L'avènement de TCO de type p ouvrira la porte à une
électronique transparente. Une des voies possibles sera peut être
celle des TCO à structure delafossite [67] comme CuAlO2, une
découverte de l'équipe d'Hosono [68].
I.3.2. Choix d'un TCO
Les oxydes ont cependant une limite supérieure de
conductivité ó et de transmission á,
déterminée par la théorie de transport des
électrons dans un métal.

oú å0 est la permittivité du vide, c la
vitesse de la lumière, n l'indice de réfraction de film, m* la
masse effective des électrons de conduction, ì la
mobilité, ë la longueur d'onde et e la charge électronique.
Puisque les TCO ont des indices proches de 2 dans le visible, le meilleur TCO
présentera le plus grand produit de mobilité et de masse
effective. Par ailleurs, dans de nombreuses applications, et en particulier
dans les systèmes d'affichage, il est souhaitable et nécessaire
que le film ait une épaisseur minimale afin de conserver une surface
aussi lisse que possible. Le paramètre important devient alors la
conductivité, c'est à dire le produit de la mobilité par
la concentration de porteurs. Cependant, en accroissant le nombre de dopants,
ces derniers se comportent alors comme des défauts neutres qui limitent
la mobilité. En comparant les TCO, on constate une concentration
d'électrons rangée dans l'ordre suivant :
ZnO :F<SnO2:F<ZnO:Al<In2O3:Sn
Enfin un paramètre important dans le choix d'un TCO,
selon son utilisation, est la température minimale de déposition.
Sur ce point précis, on constate une fois de plus que ITO et Ag sont les
plus adaptés à des dépôts sur substrat sensible
(comme les organiques).
I.4. Technique expérimentales de
dépôt des couches minces
Les principales méthodes utilisées pour
fabriquer des couches minces sous vide font appel à la technique de
dépôt en phase vapeur chimique (CVD : Chemical Vapor Deposition)
[69] et de dépôt en phase vapeur physique (PVD : Physical Vapor
Deposition) [70]. La classification des méthodes est
présentée sur le schéma de la figure I.10[71].

Figure I.b0. Présentation des principaux
procédés de dépôt de couches
minces.
I.4.1. Dépôts physiques en phase vapeur
Les procédés par PVD regroupent principalement
l'évaporation, la pulvérisation sous toutes ses formes et
l'ablation laser. Dans la réalisation d'une couche on peut distinguer
les trois étapes suivantes:
_ la création de la plume ou des espèces à
déposer, sous forme d'atomes, de molécules ou de clusters
(groupes d'atomes ou de molécules),
_ le transport de ces espèces en phase vapeur de la source
vers le substrat,
_ le dépôt sur le substrat et la croissance de la
couche.
Ce type de dépôt présente beaucoup
d'avantages par rapport au dépôt CVD.
Les films sont denses, le processus est facile à
contrôler et il n'y a pas ou peu de pollution.
I.4.1.1. La pulvérisation cathodique.
Les techniques de pulvérisation sont
généralement utilisées pour déposer toutes sortes
de matériaux : métaux, matériaux réfractaires,
diélectriques, céramiques. Des décharges de
différents types peuvent être utilisées : continues (DC) ou
alternatives (le plus souvent à haute radio fréquence (RF) : 13.6
MHz). Le principe de la pulvérisation consiste à bombarder la
surface du matériau à déposer par les ions d'un gaz
neutre, très souvent l'argon. Lors du choc avec la surface, ceux-ci
communiquent leur énergie cinétique. L'éjection d'atomes
ou de groupement d'atomes du matériau a lieu et ces derniers viennent se
déposer sur le substrat. L'ionisation des atomes d'argon est
réalisée dans une enceinte à vide qui peut atteindre
10-6 Torr. Une décharge électrique se produit dans
l'enceinte après application d'une tension entre deux électrodes
planes : une cathode où est installée la cible du matériau
à déposer et une anode qui est généralement
reliée à la masse et porte le substrat à recouvrir. Les
ions d'argon (Ar+) créés dans la décharge sont
accélérés vers la cathode et acquièrent ainsi
l'énergie qu'ils libèrent lors de leur impact à la surface
de la cible. Cela peut entraîner l'éjection d'atomes qui viennent
se déposer sur le substrat. Un schéma de principe de
fonctionnement de pulvérisation est présenté sur la figure
I.11. Les mécanismes physiques de pulvérisation sont
traités dans de nombreux ouvrages [72, 73].
Il existe plusieurs variantes de la pulvérisation
cathodique. Une très bonne synthèse de tous les systèmes
de pulvérisation est faite dans les Techniques de l'Ingénieur par
Bessot J-J [74].
Dans le cas particulier de la formation du ZnO, ou utilise une
cible de zinc, et l'on injecte conjointement à l'argon, de
l'oxygène qui s'associe au zinc pour former des molécules de ZnO.
L'intérêt de l'emploi d'une tension RF (13.56 MHz) réside
dans le fait que grâce à la différence de mobilité
entre les ions et les électrons, une auto polarisation négative
va se développer sur la surface isolante en contact avec le plasma
lorsque l'on doit déposer un isolant.
De ce fait, on va pouvoir déposer des matériaux
isolants sans accumulation de charges sur la surface de la cible, ce qui
provoquerait l'arrêt de la formation de plasma (voir figure I.11).
Mais pour qu'un tel procédé fonctionne, il faut que
:
_ La décharge soit continument maintenue durant toute
une période de la forme d'onde AC. Cette condition est
vérifiée si la fréquence est supérieure à 1
MHz. Dans ce cas, une période est plus courte que le temps
nécessaire pour charger l'isolant et éteindre la décharge
(temps de 1 à 10 ms). La plupart des plasmas sont
générés à 13,56 MHz (fréquences
réservées aux équipements industriels).
_ Les électrons perdus par la surface isolante soient
périodiquement régénérés. Cette condition
est réalisée en régime établi lorsque la charge
positive accumulée à la surface de la cible lors de l'alternance
négative est remplacée par des électrons incidents lors de
l'alternance positive.
_ Une configuration de champ électrique soit
créée dans la chambre permettant aux ions d'énergie
suffisante de bombarder et de pulvériser l'isolant de la cible. Pour
vérifier cette condition, un champ électrique doit exister en
face de la cible pour accélérer les ions avec un énergie
suffisante pour pulvériser le matériau de la cible.
Un tel champ électrique est produit dans les
systèmes RF par un phénomène appelé "auto
polarisant" ou "self-bias".
_ la pulvérisation dans la chambre soit limitée sur
toutes les surfaces excepté la cible.
Cette condition est vérifiée si la surface de la
cible montée sur une électrode est petite devant la surface de
l'autre électrode qui est constituée de la chambre et du
porte-substrat ayant un point commun avec la masse du générateur
RF.
_ la puissance RF soit accordée à la
décharge pour optimiser la vitesse de dépôt.

Figure I.11. Schéma de la technique de
pulvérisation cathodique "Sputtering"
Afin d'augmenter les vitesses de dépôts, la
plupart des bâtis de pulvérisation sont équipés
d'une cathode dite magnétron. Dans cette technique, on utilise un aimant
permanent placé dans la cathode qui permet d'appliquer un champ
magnétique parallèle à la surface de la cathode. Les
électrons dans l'enceinte sont soumis à ce champ
magnétique qui les piège autour de la cible et permet ainsi
d'augmenter le taux d'ionisation et par conséquent le taux de
pulvérisation. Pour permettre le dépôt des oxydes, des
nitrures, des sulfures et des hydrures, des gaz chimiquement actifs comme
l'oxygène ou l'azote sont introduits dans l'enceinte.
I.4.1.2. L'évaporation sous vide.
Les vapeurs du matériau à déposer sont
obtenues en chauffant celui-ci par différents moyens : effet Joule,
induction (couplage d'une génératrice haute fréquence),
canon à électrons, faisceau laser ou arc électrique.
L'évaporation est effectuée sous un vide poussé (pression
de l'ordre de 10-3 à 10-4 Pa) [75].
Comme le flux de vapeur est localisé et directionnel,
il est souvent nécessaire de soumettre le substrat à un mouvement
de rotation ou de translation par rapport à la source
d'évaporation, de manière à réaliser un
dépôt homogène et d'épaisseur uniforme. Les
meilleurs résultats sont obtenus sur des surfaces pratiquement
perpendiculaires au flux de vapeur [76]. Lorsque la pression dans l'enceinte de
dépôt n'est pas suffisamment basse les dépôts sont
peu adhérents et souvent amorphes.
D'une manière générale, les principaux
problèmes rencontrés lors d'une évaporation sont :
- la dissociation des oxydes,
- la réaction des matériaux à
évaporer avec ceux avec lesquels ils sont en contact, - les
dégazages, la décomposition, les micro-explosions des
matériaux à évaporer,
- la difficulté d'obtenir des couches d'alliages ayant la
même composition que l'alliage de départ.
L'évaporation reste toutefois une méthode
particulièrement appréciée dans l'élaboration des
matériaux très purs et d'autant plus purs que la pression est
faible, ce qui est le cas pour le procédé d'épitaxie par
jets moléculaires [75,76].
Des couches minces de ZnO dopé ou non dopé, ont
été préparées avec succès par
évaporation sous vide [77-79].
I.4.1.3. Le dépôt par ablation laser
pulsé (PLD)
La réalisation de couches minces de haute qualité
nécessite la maîtrise et le contrôle de leur
élaboration. Le choix d'une méthode de dépôt fait
intervenir plusieurs critères:
_ La nature du matériau à déposer,
_ La vitesse de dépôt et l'épaisseur de la
couche souhaitées,
_ Les contraintes imposées par le substrat
(dégazage sous vide, température maximale,...), _ La
stoechiométrie désirée,
_ La qualité cristalline et la densité des
dépôts,
_ L'adhérence du dépôt sur le substrat,
_ Enfin, la reproductibilité et le coût de la
réalisation.
I.4.1.3.1. Composition du plasma d'ablation Laser
Dans le cas de la méthode de l'ablation laser
pulsé, il est utile de présenter brièvement les
principales caractéristiques des plasmas qui sont des milieux
extrêmement complexes car composés de nombreuses espèces
chimiques. Ils sont constitués par un gaz ionisé sous l'influence
d'un champ électrique. Ce système, qui est hors équilibre
thermodynamique, peut être considéré comme le
quatrième état de la matière. Il est constitué de
particules neutres et de particules chargées.
_ Les particules neutres stables: Ce sont des atomes ou
molécules qui, pour des temps de l'ordre du temps de séjour dans
la chambre d'ionisation, ne se dissocient pas spontanément, ne
réagissent ni entre eux ni avec les parois. En général,
ils dominent en nombre toutes les autres espèces de particules.
_ Les électrons : Les électrons libres
représentent le véritable moteur des décharges
électriques. Du fait de leur masse très faible, ils se
déplacent beaucoup plus vite, à énergie égale, que
les autres espèces. Ils répondent aux perturbations
électromagnétiques sur des échelles de temps beaucoup plus
courtes que les ions. Ce sont aussi les électrons qui, du fait de leur
grande mobilité, sont responsables de la conductivité des
plasmas.
_ Les ions: Dans une ablation très puissante, les ions
sont en général de composition chimique simple mais peuvent
être multichargés.
Par contre, dans les décharges réactives
usuelles, les ions sont en général chargés une fois mais
peuvent se présenter sous forme d'édifices moléculaires
plus complexes à cause des réactions ion-molécule qui
conduisent à une polymérisation dans la phase gazeuse.
_ Les fragments moléculaires, ou radicaux libres: Un
plasma réactif contient un grand nombre de fragments moléculaires
qui, au bout d'un temps assez court, réagissent soit avec une autre
molécule, soit avec la paroi.
_ Les photons: Les photons sont le plus souvent émis
par désexcitation des états électroniques: ils sont donc
d'énergie bien définie. Les spectres de raies sont
caractéristiques des espèces émissives et sont donc
porteurs d'informations sur la composition du plasma.
I.4.1.3.2. Expansion du plasma d'ablation Laser.
Pour étudier la distribution des flux d'espèces
dans le panache, il est nécessaire de s'intéresser à
l'expansion du panache de vapeur sous vide. L'expansion du panache peut
être divisée en trois phases: la formation de la couche de Knudsen
suivie de l'expansion adiabatique du plasma, d'abord suivant une seule
dimension (la normale à la cible), puis en trois dimensions (voir figure
I.12).
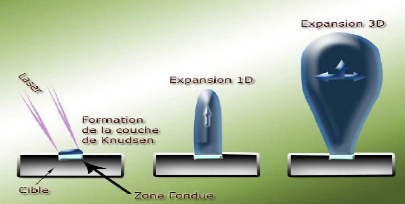
Figure I.12. Schéma des différentes
étapes de l'expansion du panache consécutif à
l'irradiation
laser d'une cible sous ultravide.
I.4.1.3.3. Le principe du dépôt.
La cible et le substrat sur lequel le film mince va être
déposé sont placés en vis-à-vis dans une enceinte
sous vide. Avant le dépôt, le substrat est chauffé à
haute température (300<T<750°C). Le faisceau laser de haute
énergie (souvent 2J/cm2) est focalisé sur une cible en
rotation du matériau massif (voir figure I.13). Le processus de
dépôt du laser pulsé est un phénomène
physique complexe. Ceci n'implique pas seulement l'interaction photonique de la
radiation de haute énergie avec la cible solide, mais aussi la formation
du plasma avec des espèces de haute énergie et le transfert du
matériau arraché de la cible au travers du plasma (la plume) vers
la surface du substrat. Le processus de dépôt par ablation laser
pulse se fait donc en plusieurs étapes :
1. Interaction de la radiation avec la cible
2. Dynamique des matériaux ayant subi l'ablation
3. Dépôt des matériaux arrachés de la
cible sur le substrat
4. Nucléation et croissance du film mince sur la surface
du substrat.
Chaque étape du processus est importante pour la
qualité cristalline et épitaxiale du film, ainsi que son
uniformité et l'obtention d'une faible rugosité de surface.
La première étape consiste en la destructuration
du matériau de la cible sur une faible
épaisseur. A une
densité de flux suffisamment forte et un temps d'impulsion assez court,
le
laser va transmettre son énergie aux atomes de la cible
en créant un champ électrique tel que les liaisons dans le solide
sont rompues. Les éléments sont ainsi dissociés de la
surface de la cible et une très forte différence de potentiel va
être créée. Les atomes vont alors être
éjectés perpendiculairement à la surface de la cible. Le
taux d'ablation instantané est fortement dépendant de la
fluence du laser (ou énergie par unité de surface
déposée par le laser) focalisée sur la cible. Les
mécanismes d'ablation impliquent plusieurs phénomènes
physiques complexes comme collisions, excitations thermiques,
électroniques et autres.
Lors de la seconde étape, il y a formation d'un plasma
et son expansion (voir image de la plume sur la figure I.13). Le
matériel arraché de la cible est ainsi transmis de la cible vers
le substrat d'après les lois de la dynamique des gaz. Ce plasma permet
le transfert des atomes ou des ions de la cible vers le substrat.
Différents paramètres jouent un rôle significatif sur la
dynamique des matériaux arrachés de la cible. Tandis que la
taille de l'impulsion laser et de la température du plasma ont des
effets sur l'uniformité du film déposé, la distance
cible-substrat va gouverner la propagation angulaire de l'ablation. La
pression du gaz introduite dans l'enceinte influence aussi l'expansion
de la plume. En effet, plus la pression dans l'enceinte est importante, plus la
probabilité de collision entre les éléments du gaz de
l'enceinte et le plasma va être grande.
La troisième étape est importante pour
déterminer la qualité du film. Les atomes ou ions projetés
sur le substrat vont se condenser et réagir avec l'atmosphère
réactive dans le bâti, ce qui conduira à la croissance du
film. Les espèces éjectées ayant une haute énergie
affectent la surface du dépôt et peuvent induire différents
types de dommages.
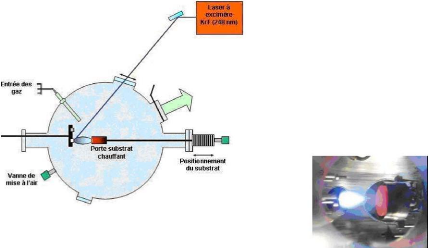
(A) (B)
Figure I.13. Schéma en coupe du bâti
d'ablation laser pulsé (A) et photo de la plume produite
par le laser
excimer (B)
Ces espèces énergétiques arrachent des
atomes de surface et une région de collision est formée entre le
flux incident et les atomes arrachés. Le film croît après
qu'une région thermalisée soit formée. La région
sert comme une source pour la condensation des particules. Lorsque le taux de
condensation est plus important que le taux de particules fournies par
l'ablation, les conditions d'équilibre thermique peuvent être
rapidement atteintes. La croissance du film sur la surface du substrat est
ainsi obtenue par rapport au flux direct des particules arrachées de la
cible et de l'équilibre thermique.
Enfin, il faut noter que la nucléation et la croissance
de films cristallins dépendent aussi de plusieurs facteurs tels que la
densité, l'énergie, le degré d'ionisation et le type de
matériel condense ainsi que la température et les
propriétés physico-chimiques du substrat. Les deux principaux
paramètres thermodynamiques dans le mécanisme de croissance sont
la température du substrat T et la sursaturation Dm. Ils
peuvent être donnés par l'équation suivante :
où k est la constante de Boltzmann, R est le taux de
dépôt et Re est sa valeur d'équilibre à
la température T [80].
Le procédé de nucléation dépend des
énergies interfaciales entre les trois phases
présentes : substrat, matériel condensé
et la vapeur. L'énergie minimum à la formation du germe
correspond à une valeur critique. La taille critique du germe
dépend de la force motrice comme le taux de dépôt et la
température du substrat. De larges germes sont caractéristiques
d'une faible sursaturation. Ceci est dû à la création
d'îlots isolés du film sur le substrat qui, par la suite,
croissent et coalescent ensemble. Si la sursaturation augmente, la taille
critique des germes diminue jusqu'à ce qu'elle atteigne le
diamètre de l'atome. Il en résulte une nucléation à
deux dimensions et leur forme serait des couches épitaxiées. Pour
de plus large sursaturation, la nucléation couche par couche va
dériver sur des couches incomplètes de croissance 3D.
Enfin, la croissance cristalline des films dépend de la
mobilité de surface des atomes arrivant (ou atomes de la vapeur).
Normalement, les atomes arrivant diffuseront sur plusieurs distances atomiques
avant de se stabiliser et former le film. La température de surface
du substrat détermine ainsi la capacité des atomes à
diffuser. De hautes températures vont favoriser la croissance rapide de
cristaux et la formation de cristaux sans défauts, tandis que de faibles
températures impliquent une sursaturation importance qui favorisent des
structures désordonnées ou même amorphes.
Metev et Meteva (1989) ont suggéré qu'à
travers la formule N99 correspond au nombre de monocouches nécessaires
pour que 99% du substrat soit recouvert. [80], l'épaisseur moyenne a
partir de laquelle la croissance des films minces discontinue atteignent la
continuité est donnée par :
où R est le taux de déposition (relié
à la sursaturation), T est la température du substrat, A est une
constante relative au matériau, Edes et
Esd sont les énergies d'activation pour la désorption des
atomes arrivant et de diffusion de surface respectivement.
Dépendant des conditions expérimentales, telles
que la densité de flux de plasma (déterminant le taux de
déposition R) et la température du substrat, différentes
structures peuvent être synthétisées allant de couches
minces monocristallines, polycristallines aux couches amorphes. Ainsi, sous
certaines conditions, une nucléation couche par couche est
favorisée et un film plat et/ou ultrafin peut être produit. De
plus, le dépôt rapide des espèces
énergétiques d'ablation aident à augmenter la
température de surface du substrat. Ainsi donc, la méthode PLD
nécessite une plus faible température du substrat pour la
croissance de films cristallins.
Le principal avantage de cette technique est donc le
mécanisme d'ablation du matériau. Contrairement à
l'évaporation thermique, qui produit une vapeur dépendante de la
pression de vapeur des éléments de la cible, l'expulsion de
matière produite sous l'impact du laser crée une plume de
stoechiométrie similaire à celle de la cible. C'est ainsi que
l'on comprend l'avantage de cette technique de dépôt lié
à la relative facilité d'obtenir un film contenant plusieurs
éléments dans les mêmes proportions
stoechiométriques que dans la cible.
De plus, cette technique permet un très bon
contrôle de croissance couche par couche, permettant d'obtenir une
épaisseur choisie. Par changement de cible, des multicouches peuvent
aussi être synthétisées.
Par exemple, les premiers super-réseaux de film
supraconducteurs ont été réalisés par Norton et
al. [81] avec les composés BaCu02/SrCu02. Des
propriétés originales peuvent être étudiées
comme le couplage d'échange magnétique entre différentes
épaisseurs de couches ferromagnétiques et
antiferromagnétiques dans les composes SrMn03/SrRu03
préparés à l'aide de la méthode PLD par Padhan
et al. [82].
I.4.2. Dépôts chimiques en phase vapeur.
Les méthodes par CVD permettent de réaliser des
dépôts à partir de précurseurs gazeux qui
réagissent chimiquement pour former un film solide déposé
sur un substrat. Les méthodes de synthèse les plus
utilisées sont :
_ le dépôt par décomposition de
composés organométalliques (MOCVD) soit à pression
atmosphérique [83] ou à basse pression [84] ;
_ le dépôt par pyrolyse d'aérosol,
appelé aussi « spray pyrolysis » à partir de solutions
aqueuses ou alcooliques est très employé surtout pour les oxydes
car les dépôts sont élaborés sous atmosphère
normale [85, 86];
le dépôt par couche atomique (ALD) [87] ou
epitaxiée (ALE) [88] et la photo-ALE [89];
_ le dépôt chimique en phase vapeur
assisté par plasma (PECVD) [90], la photo CVD [91], et récemment
le dépôt électrophorèse pour les films «
nanofils » de ZnO [92].
Les principaux avantages de ces techniques sont de permettre
la cristallisation de films sans avoir recours à un recuit, de pouvoir
contrôler la composition durant le dépôt, de réaliser
un dépôt d'épaisseur et de composition uniformes
possédant en plus une excellente adhérence.
Cependant ces techniques ont l'inconvénient de donner lieu
à des films contaminés par les résidus des
précurseurs et celui d'avoir une température de réaction
souvent élevée.
Le dépôt en phase vapeur chimique (CVD) est une
méthode dans laquelle le ou les constituants d'une phase gazeuse
réagissent pour former un film solide déposé sur un
substrat.
Les composés volatiles du matériau à
déposer sont éventuellement dilués dans un gaz porteur et
introduits dans une enceinte où sont placés les substrats. Le
film est obtenu par réaction chimique entre la phase vapeur et le
substrat chauffé. Dans certains cas, une élévation de
température est nécessaire pour maintenir la réaction
chimique. Le CVD est un domaine interdisciplinaire, il comprend un ensemble de
réactions chimiques, un processus thermodynamique et cinétique,
un phénomène de transport [93]. La réaction chimique est
au centre de ces disciplines: elle détermine la nature, le type et les
espèces présentes. Il existe deux types de réacteurs: le
réacteur à paroi chaude et le réacteur à paroi
froide. Dans le cas du réacteur à paroi chaude, ce dernier est
chauffé directement, ce qui permet d'opérer à plus faible
pression: à peu près 75 mtorr, pour lesquels des
dépôts se produisent sur les substrats, mais aussi sur les parois
(technique LPCVD : Low-Pressure Chemical Vapor Deposition [94]). Dans le cas du
réacteur à paroi froide, seul le substrat est chauffé, si
bien que la réaction n'est effective qu'au niveau du substrat
chauffé; elle se produit à pression atmosphérique. Le
principe de cette méthode de dépôt est
présenté dans la figure I.14 dans le cas de la paroi chaude.
A titre d'exemple, le dépôt d'un film de
tungstène très réfractaire peut se faire à l'aide
d'une méthode décrite par l'équation suivante :
600°C
WFgaz + 3H2 gaz > Wsolide + 6HFgaz
Cette formule implique que si l'on mélange deux gaz WF
et H2, une couche de tungstène peut être obtenue. Avec la
méthode CVD, il est possible de déposer des matériaux
métalliques, diélectriques et composites.
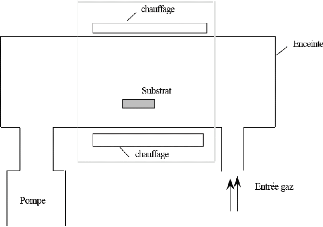
Figure I.14. Schéma de principe de
dépôt en phase vapeur chimique (CVD), réacteur à
parois
chaudes
La réaction chimique peut être activée
à l'aide d'un plasma. Cette méthode s'appelle "CVD plasma" ou
PECVD (Plasma Enhanced Chemical Vapor Deposition). Dans ce cas, il y a
création en plus de particules énergétiques [95].
La fabrication de couches minces métalliques
grâce à ces méthodes s'est particulièrement
développée ces dernières années. Les avantages de
ce procédé sont les suivants : il est facile d'obtenir un assez
grand nombre d'éléments ou de composés chimiques.
On obtient des couches de bonne qualité, un excellent
recouvrement des marches, et une bonne adaptabilité dans une
chaîne de production. De plus, elle offre la possibilité de
réaliser des dépôts sélectifs [96], ce qui permet
d'éliminer une étape de gravure et de planarisation de la
surface. Les inconvénients sont les suivants : les films sont peu
denses, ils sont souvent contaminés par des gaz très
réactifs issus de la réaction chimique (hydrogène, fluor,
chlore,...). Tous les matériaux ne peuvent être
déposés par CVD, et le système de dépôt est
une mise en oeuvre relativement lourde.
I.4.2.1. Sol-gel :
Le procédé sol-gel est l'une des voies chimiques
de préparation des matériaux de type oxyde métallique tels
que les céramiques et les verres. Il consiste tout d'abord en la mise au
point d'une suspension stable (SOL) à partir de précurseurs
chimiques en solution. Ces " sols " vont évoluer au cours de
l'étape de gélification par suite d'interactions entre les
espèces en suspension et le solvant, pour donner naissance à un
réseau solide tridimensionnel expansé au
travers du milieu liquide. Le système est alors dans
l'état " GEL ". Ces gels dits " humides " sont ensuite
transformés en matière sèche amorphe par évacuation
des solvants (on obtient alors un aérogel) ou par simple
évaporation sous pression atmosphérique (xérogel). Le
dépôt proprement dit peut être réalisé de deux
manières différentes :
· Le " spin-coating " ou centrifugation (figure1.15)
consiste à verser le sol ou le gel sur un substrat mis en rotation par
une tournette. Le liquide en excès est éjecté sous
l'action de la force centrifuge, et l'épaisseur du dépôt
est alors fonction de la vitesse de rotation du substrat et du temps de
dépôt [97].
· Le " dip-coating " ou trempé
(figure1.16) est le procédé qui consiste
à tremper le substrat dans la solution à déposer et
à le retirer ensuite avec une vitesse constante qui conditionne
l'épaisseur du dépôt [98].
Le dépôt est ensuite séché puis
recuit pour obtenir une cristallisation.
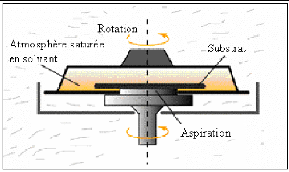
Figure I.15. Dispositif expérimental de
dépôt par spin coating.
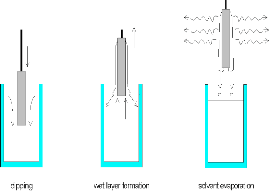
Figure 1.16. Dépôt de couches minces
par dip-coating : le substrat est immergé dans la solution
et
remonté à vitesse constante
Le choix d'une technique particulière de
dépôt de couches minces dépend de plusieurs facteurs [99].
Les derniers sont le matériau à déposer, la vitesse de
dépôt désirée, les limites imposées par le
substrat, telle que la températures maximum de dépôt,
l'adhérence du dépôt sur le substrat, le dépôt
sur des substrats complexes ou non, la pureté du matériau
envisagé pour la solution idéale et pour une solution de
remplacement, aussi les considérations écologiques et la
facilité d'approvisionnement du matériau à
déposer.
I.4.2.2. Principe général du
procédé spray.
Une solution de différents composés
réactifs est défragmentée par un atomiseur en fines
gouttelettes, puis projetée sur un substrat chauffé. La haute
température du substrat permet l'activation de la réaction
chimique entre les composés [100]. L'expérience peut être
réalisée à l'air libre si les constituants ne sont pas
nocifs [101], et peut être préparée dans une enceinte sous
un vide (environ 50 Torr) dans le cas inverse [102]. La description de
la formation des films par la méthode pulvérisation pyrolytique
« Spray pyrolysis » peut être résumée comme
suit:
· Formation des gouttelettes à la sortie du bec de
la sonde.
· Décomposition de la solution des
précurseurs sur la surface du substrat chauffé par
réaction de pyrolyse.
a.Solutions de départ (source)
La composition de la solution de départ est
déterminée par les corps ou les réactifs dissous dans le
dissolvant selon le rapport stoechiométrique
prédéterminé. Comme
précurseurs, on emploie des matériaux chimiques,
habituellement peu coûteux, tels que les nitrates, les chlorures et les
acétates qui sont rangés dans la catégorie des
réactifs [103].
L'eau distillée, ou l'alcool, est souvent
employée comme dissolvant. Dans la solution de base il est
nécessaire d'éliminer les problèmes de solubilité
et de ségrégation de phase. où les différents
composants se précipitent à des temps différents. Pour
pallier à cela et obtenir des solutions homogènes, il est
préconisé d'ajouter, pendant la préparation, une petite
quantité d'acide (par exemple, nitrique) [104-105]. La concentration
globale de la solution peut varier de 0.01 à quelques
moles/litre. Notons que ce paramètre a pour effet de changer la
taille moyenne des gouttes fluides éjectées [103].
D'après la littérature, quelques techniques
incluent le préchauffage de la solution. Ce préchauffage peut,
quelque fois, être utile et favoriser ou accélèrer la
réaction sur le substrat. Ceci permet d'accroître la vitesse de
dépôt et d'améliorer la qualité des films
résultants [102].
b.Génération des gouttelettes
(transport).
L'homogénéité du matériau
déposé peut être déterminée à partir
de la taille des gouttelettes pulvérisées et de la concentration
de la solution tandis que sa morphologie peut être également
déterminée par la concentration et la vitesse des gouttelettes
produites par les atomiseurs [100, 103]. Plusieurs méthodes
d'atomisation ont été employées dans les études de
spray pyrolyse, par exemples : pneumatique (l'air sous pression est le gaz
vecteur) [106-107], ultrasonique [105], par gravitation [102] et autres.
Dans le dispositif de dépôt, la solution de base
peut être véhiculée jusqu'au substrat sous l'effet de la
compression d'un gaz. La conduite de gaz a deux avantages, d'une part
l'écoulement peut être commandé avec beaucoup de
sensibilité et d'autre part, les gaz utilisés peuvent
également être employés en tant qu'éléments
réactifs entrant dans la composition du matériau à
déposer, tel que l'oxygène pour ZnO. Cependant, pour la plupart
des semiconducteurs composés, de l'azote N2 ou un gaz inerte est
employé pour éviter les réactions chimiques entre les
matériaux composés et /ou le dissolvant qui mèneraient
à l'addition des impuretés. Dans certains cas, et afin
d'empêcher l'oxydation des matériaux, un mélange binaire de
N2 et H2 est employé en tant que gaz porteur [107].
c.Réaction chimique sur le substrat
(dépôt).
Quand les gouttelettes d'aérosol s'approchent de la
surface du substrat chauffé (200- 600°C), dans
les conditions expérimentales appropriées, la vapeur
formée autour de la gouttelette empêche le contact direct entre la
phase liquide et la surface du substrat. Cette évaporation des
gouttelettes permet un renouvellement continu de la vapeur, donc les
gouttelettes subissent la décomposition thermique et donnent lieu
à la formation de films
fortement adhérents [108]. On note que la
réaction de décomposition en phase gazeuse, se produisant sur la
surface du substrat, est une réaction endothermique qui exige des
températures de substrat relativement élevées pour
provoquer la décomposition des gouttelettes et activer la croissance de
la couche.
Chapitre II
Préparation des films ZnO et
techniques de caractérisation
II.1.Choix d'une technique de dépôt de
couches minces
Dans cette étude, la méthode de l'ablation laser
pulsé (PLD) est utilisée pour réaliser des
dépôts de ZnO non dopé et dopé Al (AZO) sur des
substrats en verres et de silicium chouffés à 450 °C.
II.2.Conditions expérimentales de
dépôt.
- L'enceinte de dépôt est munie d'un hublot en
quartz, positionné à 45o par rapport à la
normale à la cible qui est en rotation, alors que substrat est maintenu
fixe durant tout le processus de dépôt. La distance cible-substrat
est fixée à environ 40 mm (ZnO) et 57 mm (AZO).
- Le groupe de pompage comporte une pompe primaire à
palettes et une pompe secondaire à diffusion d'huile, ce qui permet
d'atteindre un vide proche de 5x10-5 mbar avec une pression relais
de 10-2 mbar.
- Le laser utilisé dans cette étude est une
source laser excimer KrF LAMBDA physic délivrant des impulsions de 25 ns
à une longueur d'onde égale à 248 nm avec une
fréquence de 5 Hz. la fluence laser est égale à 2
J/cm2.
- La pression d'oxygène est environ 10-2
mbar.
- Avant le dépôt, le substrat est chauffé
à haute température (~ 450°C) II.2.1.
Préparation des substrats.
Les propriétés de la couche
déposée sont fortement liées à la nature du
substrat. Ainsi, une couche mince d'un même matériau, de
même épaisseur pourra avoir des propriétés physiques
sensiblement différentes selon qu'elle est déposée sur un
substrat isolant amorphe tel que le verre, un substrat monocristallin de
silicium, ou un substrat Si-Polycristallin. Donc il résulte de cette
caractéristique essentielle qu'une couche mince est anisotrope par
construction.
Les substrats utilisés dans ce travail sont des lames
de verre de surface environ 1cm2 et d'épaisseur 1mm, des
plaquettes de silicium monocristallin Si(100) et Si(111). Et de silicium
polycristallin (Si-poly) d'épaisseur environ 0.5 mm. Les
échantillons préparés sur du verre sont transparents, ce
qui permet d'étudier la transmission optique dans le domaine UV-vis.
La qualité des couches déposées
dépend de l'état de surface et de la propreté du substrat.
Le nettoyage de ce dernier est donc une étape très importante
dans la préparation des échantillons.
Les substrats sont nettoyés suivant les étapes
suivantes :
- Nettoyage dans l'eau distillée dans un bain ultrason
pendant 15 min,
- Rinçage avec l'eau distillée,
- Nettoyage avec le méthanol pendant 5 min,
- Nettoyage avec l'acétone pendant 5 min pour Si,
- Séchage avec un papier optique.
Une fois nettoyés, les substrats sont placés dans
l'enceinte de dépôt et le pompage est lancé.
II.3. Préparation des cibles.
Les cibles peuvent être de différentes natures
comme des poudres pressées, des agrégats frittés, des
matériaux moulés, des cristaux simples ou des feuillets
métalliques. La principale différence entre ces
différentes cibles réside dans la nature de l'érosion et
la génération de particules. Des cibles céramiques
frittées caractérisées par une forte densité et une
bonne homogénéité produisent les meilleurs films. Dans
notre étude, les cibles ZnO et AZO ont été
fabriquées par les techniques classiques de la céramique. Les
produits utilisés sont deux poudres d'oxydes ZnO (99.0% FLUKA
Analytical) et Al2O3 (99.9 % ALDRICH CHEMICAL Company). Dans un
premier temps on effectue la pesée, et les quantités
nécessaires sont calculées pour obtenir une pastille circulaire
de diamètre 15 mm et d'une épaisseur d'environ 2 mm. Le
mélange des deux oxydes va subir une première étape de
chamottage, puis il est pressé dans un moule sous 2 tonnes. La pastille
obtenue est frittée à l'ambiante.
Pour cette étude, on a fabriqué trois cibles de
composition différentes. La première cible représente du
ZnO pur. Les deux autres cibles sont du AZO avec 3% et 5% en masse Al. Il est
important de noter que la cible doit :
> avoir une très bonne tenue des les conditions
thermiques développées par le faisceau laser incident,
> avoir une très bonne adhérence au porte-cible
pour assurer un bon contact thermique, > être inerte vis-à-vis
des constituants du plasma.
II.3. Technique de caractérisation.
II.3.1.Diffraction des rayons X (DRX).
La technique de la diffraction des rayons X permet de
déterminer principalement cristalline des couches déposée,
la taille des cristallites et les contraintes internes exercées sur les
films.
Principe d'analyse.
Lorsqu'un faisceau de rayons X monochromatique est dirigé
sur un matériau polycristallin, il est en partie réfléchi
par certains plans atomiques cristallins (figure II.1).

Figure. II.1. Famile de plans cristaiins en
condition de Bragg.
La condition de diffraction des rayons X est donnée par la
loi de Bragg :
2 d(hkl) . Sinè = n . ë
(II.1)
où dhkl est la distance
interéticulaire séparant les plans définis par les indices
de Miller (h, k, l), è l'angle d'incidence et donc de réflexion
par rapport à ces plans et, ë la longueur d'onde des photons X,
incidents.
Le diffractogramme est un enregistrement de l'intensité
diffractée en fonction de l'angle 2è formé avec le
faisceau incident. Le dépouillement du diffractogramme permet de
remonter à un grand nombre d'informations sur les
caractéristiques structurales et microstructurales de
l'échantillon telles que la structure cristalline, la taille des
cristallites, les contraintes et la texture [109].
Les positions angulaires des raies de diffraction sont
caractéristiques des paramètres du réseau cristallin, ce
qui permet donc de remonter au réseau cristallin de chacune des phases
cristallisées de l'échantillon.
Les positions angulaires et les intensités des raies de
diffraction X de la plupart des matériaux connus ont été
étudiées et répertoriées dans des bases de
données. La comparaison d'un diffractogramme expérimental avec
ces données permet de définir la nature de chaque phase
constitutive de l'échantillon.
Dans le cadre de notre la présente étude, le
diffractomètre utilisé est de marque BRUKER - AXS type D8. Les
rayons-X sont été produits à partir d'une source de
radiation CuKá, ayant une longueur d'onde égale à 1.541838
Å, en appliquant sur la cathode une tension d'accélération
de 40kV et un courant de 40 mA (figure II.2).

Figure. II.2. diffractomètre de marque
BRUKER - AXS type D8.
Le spectre de DRX d'une poudre de ZnO stoechiométrique
standard, selon fiche JCPDS N° 36-1451(figure II.3), est
présenté sur la figure.II.4 [110].

Figure II.3 : Fiche JCPDS de ZnO.
Ce spectre de diffraction X propre ou composé ZnO
constitue une référence pour l'identification des pics de
diffraction enregistrés sur les échantillons ZnO et AZO soumis
à l'étude.

200
Intensite (u.a)
(100)
1000
400
J 41. 0)
) 0 0
) 0 0
600
800
0
(002)
(101)
(102)
(110)
(200) (103)
(112)
(201) (004)
(202)
(104)
10 20 30 40 50 60 70 80 90
2è
Figure.II.4. Spectre de diffraction des rayons-X
d'une poudre de couche mince de ZnO[110].
Détermination de la taille des grains et des
contraintes.
La taille des gains des filmes des différents
échantillons a été déduite tout d'abord à
partir des spectres de diffraction des rayons X en utilisant la relation de
Scherrer [111,112].

où :
D est la taille des grains ([D] = nm), ë est la
longueur d'onde du faisceau de rayons X, è est l'angle de diffraction et
â est la largeur à mi-hauteur exprimée en radian (figure
II.5).

Figure II.5. Illustration montrant la
définition de â à partir du pic de diffraction des rayons
X
Détermination des contraintes.
L'effet des contraintes se traduit sur les diffractogrammes
par un déplacement des pics de diffraction. La comparaison entre les
fiches J.C.P.D.S. et l'enregistrement expérimental des spectres dans les
échantillons permet de déterminer les paramètres de
mailles. En effet à chaque angle de diffraction correspond des plans
atomiques (h, k, l) de distance interréticulaire donnée d par la
formule de Bragg. Dans le cas du composé ZnO de structure hexagonale, la
distance dhkl qui correspond aux indices h, k et l est reliée
aux paramètres de la maille par la forme suivante :

a et c étant les paramètres de maille.
De cette formule, on peut déterminer le paramètre c
en prenant dans la mesure du possible les plans pour lesquels h=k=0, l=2.
La mesure des paramètres de la maille donne une
indication sur l'état des contraintes à l'intérieur des
couches déposées, sachant que le paramètre c de ZnO en
l'absence de contraintes admet une valeur c0 = 5.205 A.
Les contraintes internes peuvent être calculées
à partir des expressions suivantes [113] :

;
avec et
Cij sont les constantes élastiques de ZnO qui admettent
les valeurs suivantes [113]:
C11= 209.7 GPa, C12 = 121.1 GPa, C13 = 105.1 GPa, C33 = 210.9
GPa.
II.3.2. Microscopie à force atomique (AFM)
Le principe de microscope à force atomique l'AFM
consiste à déplacer une pointe située au bout d'un levier
à la surface d'un échantillon qui peut être conducteur ou
non conducteur (figure II.6). Cette surface d'échantillons.

Figure II.6. Schéma de principe d'un
AFM.
La déflexion du levier, résultant des forces
d'interaction pointe/surface est enregistrée à l'aide d'un laser
et d'un détecteur (figure II.6). L'image, obtenue par microscopie
électronique MEB d'une pointe AFM est reportée sur la figure
II.7. Le rayon en bout de pointe est de l'ordre de 20 à 60 nm alors que
la constante de raideur du levier varie de 0.5 à 0.006 N/m. Les forces
d'interaction mesurées sont de l'ordre de 10-6 à
10-8 N.
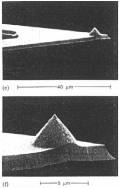
Figure II.7. Image d'une pointe AFM
fabriquée en Si3N4.
La figure II.8 indique également, selon la distance pointe
/ surface, le type de force qui s'exerce sur la pointe (attractive ou
répulsive). Ces forces peuvent avoir des origines diverses.
Il peut s'agir de force de type Van der Waals, de forces
magnétiques, électrostatiques ou encore capillaires selon la
nature de l'échantillon analysé. On distingue deux modes
d'utilisation de l'AFM et qui sont schématisés sur la figure
II.8. Le mode contact (forces répulsives) correspond au cas où la
pointe est systématiquement en contact doux avec la surface. Par contact
doux, il faut comprendre un contact tel que les forces de contact soient
inférieures en norme aux forces de liaison qui existent au sein de
l'échantillon. Le mode vibrant utilise une pointe en vibration
permanente de telle sorte que la pointe touche l'échantillon uniquement
au plus bas de la déflexion. Ce mode permet une résolution
latérale meilleure (1 à 5 nm) et permet d'analyser des
échantillons mous.
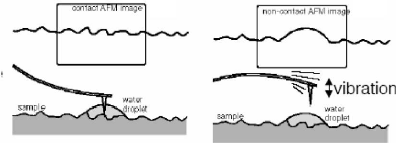
(a) (b)
Figure II.8. Mode contact (a) et mode vibratoire
(b) en AFM.
La résolution verticale d'un AFM est inférieure
à 1 Å. Deux images obtenues par AFM sont reportées sur les
figures II.9 et II.10.
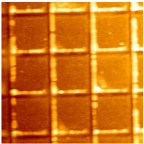
Figure II.9. Grille d'or (3.5 x 3.5 um) avec une
échelle verticale de 0 à 150 nm obtenue par AFM en
mode
contact.

Figure II.10. Chromosomes humains visualisés
par AFM en mode vibratoire.
La morphologie de surface des couches élaborées
a été analysée à l'aide d'un microscope à
force atomique (PACIFIC NANOTECHNOLOGY) en mode contact. La résolution
de l'appareil est de 2um en X et Y. Les leviers utilisés sont en nitrure
de silicium.
II.3.3. Analyse RBS.
a) Principe de la spectroscopie RBS.
La spectroscopie de rétrodiffusion de Rutherford RBS
est basée sur la mesure des énergies des particules
rétrodiffusées lorsqu'on bombarde un matériau par un
faisceau d'ions de haute énergie (de 1 à 5 MeV). Il s'agit d'une
méthode quantitative qui permet d'identifier et de quantifier les
différents constituants d'une couche mince, sur une épaisseur de
plusieurs centaines d'Angströms. Un accélérateur Van de
Graaf génère des particules 4He+
monocinétiques. Les particules incidentes sont
rétrodiffusées élastiquement par les atomes de la couche,
leur direction et leur énergie sont alors modifiées. Connaissant
l'énergie des ions rétrodiffusés, il est possible d'en
déduire la nature de l'élément sondé, la
composition les éléments et l'épaisseur de la couche. Le
schéma de principe de la spectroscopie de rétrodiffusion de
Rutherford (RBS) est représenté sur la figure II.11. Le spectre
obtenu donne pour chaque élément détecté un pic
dont la largeur et l'aire sont proportionnelles respectivement à
l'épaisseur x de la couche au nombre d'atomes par unité de
surface (figure II.12). Les trois paramètres les plus importants sont le
facteur cinématique K, la perte d'énergie ÄE et l'aire du
pic A. En effet, ces derniers permettent d'identifier la nature de
l'élément analysé, l'épaisseur de la couche (x) et
surtout le nombre d'atomes par unité de surface.

Figure II.11: Schéma de principe de la
spectroscopie de Rutherford RBS. E0 correspond à l'énergie
des
particules incidentes avant la collision, E1 est l'énergie d'un ion
rétrodiffusé à la surface de la
couche mince et E2 est
l'énergie d'un ion rétrodiffusé après avoir
parcouru l'épaisseur x de la
couche mince.




Figure II.12. Spectre RBS théorique d'une
couche mince constituée d'un seul
élément.
1- Le facteur cinématique K.
L'énergie d'un ion rétrodiffusé après
la collision (E1) est proportionnelle à son énergie avant la
collision avec un atome de la couche (E0):
E1= k.E0
La détermination du facteur K suppose que la collision
entre les particules incidentes et les atomes de la couche mince est
élastique. Ainsi, lorsqu'un ion incident 4He+ de
masse M1 et de vitesse constante subit une collision avec un atome immobile de
masse M2, son énergie est partiellement transférée
à l'atome immobile, à condition que des réactions
nucléaires n'aient pas lieu. Le facteur cinématique K est
donné par la relation suivante:

K= =
K dépend donc des masses des deux particules qui
entrent en collision et de l'angle de rétrodiffusion. Ainsi, la
connaissance de la masse M1 des ions 4He+ et des
énergies E0 (fixée) et E1 (mesurée) permet de
déterminer la masse M2 des atomes de la couche et la nature de
l'élément sondé.
2- La perte d'énergie ÄE
L'ion rétrodiffusé à la surface de la
couche possède une énergie E1= k.E0, E2 est l'énergie de
l'ion rétrodiffusé après avoir parcouru l'épaisseur
x de la couche. Le spectre RBS donne pour chaque élément un pic
qui est caractérisé par une perte d'énergie ÄE.
Celle-ci est donnée par la relation suivante:
ÄE= k.E0 -E2 = [å].N.x
N est le nombre d'atomes par unité de surface et
[å] est le facteur de section efficace d'arrêt. Ce dernier est
relié à l'angle 01 (angle entre le faisceau d'ions incidents et
la normale à la couche) et à l'angle 02 (angle entre la normale
à la couche et la trajectoire d'un ion rétrodiffusé) par
la relation suivante:

et représentent les pertes d'énergie lorsque les
ions traversent la couche
respectivement vers l'intérieur et vers
l'extérieur. Ainsi, à partir de la perte d'énergie ÄE
et du facteur de section efficace d'arrêt, il est possible de
déterminer l'épaisseur x de la couche.
3- L'aire du pic.
Pour chaque élément, l'aire du pic A est
reliée au nombre N d'atomes par unité de surface et est
donnée par la relation suivante:
A= a.?.Q.N.x
a est la section efficace, ? est l'angle solide sous-tendu par
le détecteur et Q est le nombre
d'ions incidents heurtant la couche
mince. Connaissant le nombre d'atomes N par unité de
surface pour
chaque élément constituant la couche, il est possible de
déterminer la
composition de la couche, le rapport atomique étant
proportionnel au rapport des aires des pics:

NA est le nombre d'atomes de l'élément A par
unité de surface, NB est le nombre d'atomes de l'élément B
par unité de surface, AA et AB sont respectivement les aires des pics
correspondant à l'élément A et à
l'élément B.
L'aire du pic est proportionnelle à la section efficace.
Ainsi, la section efficace différentielle s'exprime par la relation
suivante:

Z représente le numéro atomique.
La section efficace différentielle est donc
proportionnelle au carré du numéro atomique
(étant la charge élémentaire d'un
électron). Ainsi, plus Z est grand, plus l'aire est grande.
La spectroscopie RBS est une méthode d'analyse
élémentaire non destructive particulièrement bien
adaptée pour l'étude des couches minces. Elle permet une analyse
quantitative simultanée de tous les éléments
présents dans la couche. La forme des pics caractéristiques de
chaque élément peut indiquer l'existence d'éventuels
gradients de concentration. La limite de sensibilité de cet est de
quelques pourcents et est fonction du numéro atomique.
La figure II.13 représente un spectre RBS typique d'un
film mince ZnO sur silicium. Les différents pics détectés
permettent d'identifier les éléments contenus dans le film mince.
Les éléments sont séparés grâce à leur
position en énergie. Le rapport des hauteurs respectives des pics de
rétrodiffusion permet d'obtenir la composition relative de chaque
élément. La largeur d'un pic est reliée à
l'épaisseur sur laquelle l'élément est présent.
Enfin, un front de descente présentant une sorte de queue indique une
dispersion en énergie des ions rétrodiffusés causée
soit par une rugosité de surface importante ou par des
phénomènes d'interdiffusion entre les éléments du
film mince et du substrat.
Les spectres énergétiques RBS sont simulés
à l'aide du programme universel rump.

Figure II.13. Spectre RBS typique d'une couche mince
de ZnO/Silicium. b) Conditions expérimentales
> Energie : 2MeV > Faisceau : 4He+ > Courant du
faisceau ? 50 nano ampère
> Angle de détection : 165°
> Incidence normale « ö=0 »
> FWHM ? 45°
> Charge ? 5-7 ìCoulombs
II.3.4. Caractérisation optique.
Comme déjà indiqué
précédemment, l'oxyde de zinc présente des
propriétés optiques intéressantes pour diverses
applications, en particulier en optoélectroniques.
L'étude des propriétés optiques des
échantillons permet de déterminer le seuil d'absorption optique,
le coefficient d'absorption, la largeur de la bande interdite, l'énergie
d'Urbach et l'indice de réfraction [114].
Les spectres de transmission ont été
enregistrés sur un spectrophotomètre UV-Vis de type UV-310
PC-SHIMADZU à double faisceau .Ce dernier est constitué de lampes
comme source lumineuse, de monochromateur pour sélectionner la longueur
d'onde et de détecteurs. Ce spectrophotomètre est
équipé d'un double faisceau qui permet de soustraire l'influence
du substrat et d'acquérir le spectre de transmission de la seule couche
étudiée. Le principe de fonctionnement de l'appareil de mesure
est représenté sur la figure II.14.

Figure II.14. Représentation
schématique du spectrophotomètre UV-Visible.
On a utilisé la méthode de Swanepoel [115] qui
permet la détermination des caractéristiques optiques à
partir du spectre de transmission enregistré dans le domaine de
l'ultraviolet et du visible. La mesure du spectre référentiel est
effectuée pour une lame de verre qui est transparente optiquement dans
la gamme spectrale considérée. La mesure proprement dite est
réalisé pour les échantillons constitues du film AZO et du
substrat en verre. La gamme spectrale s'étend de la longueur d'onde
ë = 200 à 800 nm avec une résolution de 5 nm. Les spectres
obtenus représentent la variation relative de la transmittance T optique
de la couche en fonction de la longueur d'onde ë.
Le graphique de la figure II.15 donne l'exemple d'un spectre de
transmission mesuré sur une couche d'oxyde de zinc déposée
sur un substrat en verre.
On définit Tmoy comme la valeur de la moyenne
de la transmission dans le domaine du visible (400 nm à 800 nm).
Tmoy est égale à 90 % dans le cas de la figure
II.15.
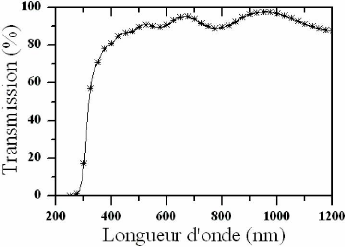
Figure II.15. Spectre de transmission optique d'une
couche d'oxyde de zinc déposée sur du verre.
A partir du spectre de transmission de la couche mince on peut
calculer les coefficients d'absorption á et d'extinction k du
matériau qui la constitue, en utilisant les deux relations suivantes
:

où d est l'épaisseur du film et T étant la
transmittance.
La détermination du gap optique Eg est basée sur le
modèle proposé par Tauc [118], où Eg est relié au
coefficient d'absorption par :



A est une constante reflétant le degré de
désordre de la structure solide amorphe, Eg est
exprimé en eV, hõ est l'énergie du photon en eV
(hõ = = .

En traçant en fonction de hõ, on peut
déterminer par extrapolation jusqu'à , la valeur du gap optique
Eg (figure II.16).
Un autre paramètre important qui caractérise le
désordre du matériau est l'énergie de queue d'Urbach.
D'après la loi d'Urbach l'expression du coefficient d'absorption est de
la forme [119]:

En traçant lná en fonction de hõ, on peut
accéder à la valeur de Eg (figure II.17).


(aM'f
1,40E+011
1,20E+011
1,00E+011
8,00E+010
6,00E+010
4,00E+010
2,00E+010
0,00E+000
1 2 3 4 5 6 7
-2,00E+010
hí(ev)
Figure II.16. Détermination du gap
d'énergie par extrapolation à partir de la variation de
(áhõ)2 en
fonction de hõ.

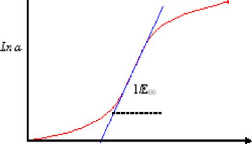

Figure II.17 : Détermination du
désordre par l'extrapolation à partir de la variation de ln
á en
fonction de hí.
Les constantes physiques utilisées dans les calculs sont
donn »es dans la figure III.19.






Figure II.18. Système d'une couche mince
absorbante sur un substrat transparent épais.
T est le coefficient de transmission, a est le coefficient
d'absorption du film, X est la longueur de la lumière incidente, n et s
sont les indices de réfraction du film et du substrat respectivement, d
représente l'épaisseur du film.
Dans le cas d'une couche épaisse et lisse, des
réflexions multiples de la lumière ont lieu entre la surface
inférieure en contact avec le substrat et la surface libre de la couche.
Il en résulte alors dans le spectre de transmission des franges
d'interférences avec des minima et des maxima en fonction de la longueur
d'onde. Soient X1 et X2 les longueurs d'onde de deux maxima consécutifs,
TM1 et TM2 les transmissions respectives, Tm la transmission du minima qui se
trouve entre les deux maxima (FigureIII.18). L'épaisseur de la couche
est déterminée à partir de la relation suivante [120,121]
:

Les indices de réfraction n1 et n2 de la couche pour les
longueurs d'onde X1 et X2 sont tirés de la relation :

S : indice de réfraction du substrat
et N1,2 peut être calculé à l'aide de la
relation :


Figure II.19. Franges d'interférence pour
optiques.
L'indice de réfraction des différents
échantillons a été déterminé tout d'abord
à partir de la valeur du gap optique. Afin de s'assure des valeurs de
l'indice de réfraction des films, on a utilisé la relation
suivante [122]:

n est indice de réfraction de la couche à analyser
et Eg son gap optique. Eg : gap optique
Chapitre III
Résultats et discussions
III.1. Analyse par RBS.
L'oxyde ZnO est non stoechiométrique quand il est sous
forme de couches minces et selon la littérature sa composition influe
énormément sur ses caractéristiques physo-chimiques. Il
devient donc légitime de s'interroger sur la proportion des
éléments présents. Les spectres énergétiques
obtenus par la méthode RBS permettent de déterminer, en plus de
l'épaisseur du film, la proportion d'oxygène et de zinc, formant
la couche non dopé, et aussi la teneur de l'élément dopant
Al.
La figure III.1.a montre un exemple de spectre RBS
expérimental et simulé d'une couche mince d'oxyde de zinc non
dopé déposée sur un substrat de Si(100). Le spectre RBS
est constitué d'un signal Zn du côté des hautes
énergies et d'un signal O du côté des faibles
énergies. Le plateau énergétique apparaissant entre ces
deux pics correspond à Si du substrat. La simulation de ce spectre
à permis d'estimer à 370 nm l'épaisseur de la couche ZnO
et déterminer les compositions atomiques moyennes de Zn et O de valeurs
57.8 et 42.2 %at respectivement. Il ressort de cette analyse RBS que l'oxyde de
zinc formé non stoechiométrique avec un manque d'oxygène
et donc un excès de zinc.
Energy (MeV)
0.5 1.0 1.5

Normalized Yield
40
20
30
10
0
Experimental Simulation
O Si
Zn
100 200 300 400 500 600 700
Channel
Figure III.1.a. Spectre RBS expérimental et
simulé d'une couche mince d'oxyde de zinc
déposé sur un
substrat Si(100).
La figure III.1.b représente le spectre d'analyse RBS
enregistré dans une couche mince d'oxyde de zinc dopé 3 %at
aluminium et déposée sur un substrat de Si(100)
(échantillon AZO3). On voit clairement que l'aspect du spectre RBS est
analogue à celui de la figure III.1.a, c'est à dire il est
constitué de trois signaux relatifs à l'oxygène, le
silicium et le zinc. Les valeurs des compositions atomiques obtenues par
simulation RBS sont 40.5 % O, 57 % Zn et 2.5 % Al. Il est intéressant de
constater que c'est le zinc qui est toujours en excès et que la
concentration atomique de l'aluminium est très proche de sa valeur
nominale. Cependant, la couche AZO3 admet une épaisseur égale
à environ 210 nm, nettement inférieure à celle du film ZnO
non dopé. Ce fait peut être facilement confirmé en
superposant les deux spectres RBS. Le signal RBS de Zn est plus large en
énergie dans le premier cas, sachant que l'étendue
énergétique des signaux RBS des éléments
proportionnelle à l'épaisseur renfermant ces
éléments.
Energy (MeV)
0.5 1.0 1.5

Normalized Yield
40
20
30
10
0
____ Experimental ____ Simulation
O SiAl
Zn
100 200 300 400 500 600 700
Channel
Figure III.1.b. Spectre RBS expérimental et
simulé d'une couche mince d'oxyde de zinc dopé
3%at. aluminium
AZO3 et déposée sur du substrat Si(100).
La figure III.1.c montre le spectre RBS correspondant à
l'échantillon AZO5 formé couche mince d'oxyde de zinc dopé
au 5 %at. aluminium déposée sur un substrat de Si(100). D'une
façon analogue aux ces précédents, la simulation RBS a
abouti à la valeur de l'ordre de 120 nm
pour l'épaisseur du film AZO5 et aux concentrations
atomiques 63.6 % Zn, 31.7 % O et 4.7 %
Al. Ces dernières confirment
l'excès de zinc par rapport à la composition
stoechiométrique et la
concentration atomique nominale de Al proche
de la valeur mesurée expérimentalement par RBS.
Il ressort donc que le procédé de
dépôt par ablation laser n'affecte pas la composition du dopage de
la couche par rapport à la cible pulvérisée. Par contre,
le transport des éléments Zn et O depuis la cible vers le
substrat n'est pas stoechiométrique avec un défaut
d'oxygène.

____ Expérimental
____ Simulation
Figure III.1.c. Spectre RBS expérimental et
simulé de l'échantiion AZO5 formé d'une couche
mince
d'oxyde de zinc dopé à aluminium (5%at.) sur un substrat
Si(100).
Les spectres des figures III.1 sont constitués des signaux
relatifs au zinc (~1.5 MeV), au silicium (~ 1.1 MeV), au aluminium (~ 1 MeV) et
à l'oxygène (~ 0.7 MeV).
La distribution des atomes Al dans la matrice de ZnO est
homogène tout au long de l'épaisseur de la couche mince et il n'y
a aucune évidence quant à d'éventuelles
inhomogénéités de concentrations.
Après avoir effectué les caractérisations
RBS nécessaires à la détermination des épaisseurs
et de la composition quantitative des éléments Zn, O et Al
formant les couches minces ZnO et AZO, ou procède maintenant à
l'analyse structurale des échantillons élaborés par le
procédé PLD.
III.2. Analyse par diffraction des rayons X
III.2.1. Effets du dopage
III.2.1.1 Substrat de verre
Les couches minces ZnO présentent
généralement une structure de type wurtzite. Sur la figure III.2
sont présentés les diffractogrammes des couches d'oxyde de zinc
ZnO, non dopé et dopé aluminium (AZO), déposées sur
des substrats de verre. Deux pics de diffraction sont enregistrés pour
des angles de diffraction égaux à 2è de 34,4 et
72,4°. Ces pics correspondent aux plans de diffraction (002) et (004) de
la structure hexagonale wurtzite respectivement. Comme il a été
prouvé par d'autres chercheurs [123, 124], les couches AZO
présentent une croissance préférentielle suivant l'axe
cristallographique C. On remarque également que l'intensité du
pic (002) diminue avec le dopage. Ceci atteste de l'amélioration de la
qualité cristalline des couches ZnO et AZO.
20 30 40 50 60 70 80
2è
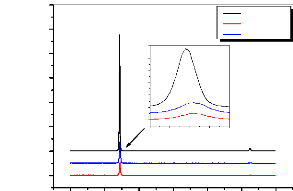
Intensite (u.a)
14000
12000
10000
4000
2000
8000
6000
0
(002)
12000
10000
8000
6000
4000
2000
0
34,0 34,2 34,4 34,6 34,8
ZnO/Verre ZAO3/Verre ZAO5/Verre
(004)
Figure III.2. Spectres de diffraction des rayons X
(è-2è) des couches minces ZnO et AZO
déposées
sur un substrat de verre.
De plus, aucun pic relatif à Al ou Al2O3 n'a
été observé dans les couches AZO. A partir de ces
diagrammes de diffraction, on peut conclure que l'incorporation de l'aluminium
comme élément dopant n'affecte pas le réseau du ZnO (dans
le cas d'une cible avec 3 et 5% Al2O3 en masse). Ce résultat
est en bon accord avec les travaux de Tang et al [125].
Pour ZnO pur, le pic (002) apparaît à
34.36°, alors que pour les échantillons AZO dopés 3 et 5%
atomique Al les pics (002) se positionnent à 34.44°. Les pics de
DRX se déplacent vers les fortes valeurs de è avec le dopage en
aluminium des films AZO. Ce décallage angulaire correspond à une
diminution du paramètre c, c'est à dire de la distance inter
réticulaire qui est égale à c/2 pour la famille des plans
(002) dans la structure hexagonal wurtzite. Les valeurs du paramètre c
de la maille, déduite à partir de la DRX des films ZnO et AZO,
varient entre 0.5208 et 0.5220 nm (tableau III.1). Elles sont
légèrement supérieures à la valeur 0.51948 nm
correspondant à la poudre ZnO selon les fiches JSPDS.
Tableau III.1. Variation des paramètres du
réseau cristallin des films minces ZnO et AZO déposés sur
substrat de verre.
|
films
|
2è (°)
|
Taille des
grains (nm)
|
Distance inter
réticulaire (nm)
|
Contrainte (GPa)
|
Paramètre de la
maille c (nm)
|
|
ZnO
|
34.36
|
37
|
0.2610
|
-0.6709
|
0.5220
|
|
3 %at. Al: ZnO
|
34.44
|
27
|
0.2604
|
-0.1342
|
0.5208
|
|
5 %at. Al: ZnO
|
34.44
|
25
|
0.2604
|
-0.1342
|
0.5208
|
Cette diminution du paramètre de réseau est
produite trés probablement par l'incorporation des atomes Al
(AL+3) dans les sites substitutionnels Zn (Zn+2) dans la
couche formée [126-128]. Comme le rayon de l'ion Al+3 (0.53
Å) est plus faible que celui de l'ion Zn+2 (0.72 Å),
cette substitution conduit à une contraction du réseau.
D'après la littérature [129, 130], le paramètre
cristallographique c croît ou diminue en fonction des paramètres
expérimentaux de croissance des films minces AZO. Il est à noter
que la diminution de la distance inter-réticulaire à pour effet
de diminuer l'indice de réfraction du film. Aussi, le dopage par Al
affecte la qualité cristalline qui se traduit par l'accroissement de la
largeur à mi-hauteur des pics DRX avec la teneur Al.
Ceci indique qu'il y a une mauvaise cristallinité
suivant l'orientation c et une réduction de la taille des grains des
films. La taille des grains est calculée en utilisant la formule de
Debye- Scherrer. Cette décroît, d'environ 37 à 25 nm quand
la concentration atomique de l'aluminium varie de 0 à 5%.
Bien que cette méthode ne prenne pas en
considération la contribution des contraintes dans la largeur à
mi-hauteur du pic de diffraction utilisé pour le calcul, elle donne une
bonne estimation de la taille des cristallites et plus particulièrement
dans le cas des cristallites de petite taille [131]. La variation de la taille
des grains en fonction du pourcentage d'aluminium des films AZO
déposés sur substrat en verre est représentée sur
la figure III.3. On remarque que la taille des grains des films AZO diminue
avec le dopage en aluminium.
La couche mince non dopée ZnO présente des grains
de taille plus grande, caractérisée ainsi par une meilleure
cristallinité par rapport aux autres couches dopées l'aluminium
AZO.
Taille des grains (nm)
38
36
34
32
30
28
26
24



Figure III.3. Variation de la taille des grains des
couches minces ZnO et AZO déposée sur un
substrat en verre en
fonction du taux de dopage aluminium.
Les contraintes dans les films ont été
estimées à partir des spectres de diffraction des rayons X en
exploitant le décalage de la position du pic (002). Les détails
du calcul ont été présentés dans le chapitre
précédent relatif aux techniques expérimentales. La
variation de la contrainte en fonction du dopage d'aluminium est
rapportée sur la figure III.4.
Les contraintes mettent en jeu une énergie qui tend
à provoquer la migration des atomes de dopage Al vers des sites plus
stables an sein du réseau cristallin de l'oxyde ZnO.
D'une manière générale, le dopage de film
et la présence des impuretés sont des moyens très
efficaces pour augmente ou réduire les contraintes internes du film. Les
contraintes dans les films ZnO ont été estimées à
partir décalage angulaire de la position du pic (002) des spectres de
diffraction X par rapport à la position assignée à ZnO
pur. Les valeurs des contraintes trouvées dans les couches
considérées sont situées entre (-0,6709) GPa et (-0,1342)
GPa.
L'amélioration de la cristallinité et de la
taille des grains dans une couche mince de ZnO est à l'origine de la
diminution des contraintes, et c'est la même conclusion qui a
rapportées par kim et al [132].

Contrainte (GPa)
-0,1
-0,2
-0,3
-0,4
-0,5
-0,6
-0,7
-0,8
Figure III.4. Variation des contraintes dans les
couches minces ZnO et AZO déposées sur un
substrat de verre
pour différents taux de dopage en aluminium.
III.2.1.2. Substrat de silicium Si(100)
Sur la figure III.5, on a présenté les
diffractogrammes des couches d'oxyde de zinc, non dopé ZnO et
dopés aluminium AZO, déposées sur des substrats de
Si(100). En plus des raies Si(200) et Si(400), deux enregistrés pour des
angles de diffraction 2è coïncidant avec 34,5 et 72,8° qui
correspondent aux plans (002) et (004) de la structure hexagonal wurtzite. Les
couches AZO présentent une croissance préférentielle
suivant l'axe C. On remarque également que l'intensité du pic
(002) diminue avec le dopage 5% atomique aluminium, mais elle subit une forte
augmentation dans le cas du dopage 3%. Aucun pic lié à Al ou
Al2O3 n'est observé dans les couches AZO, comme
indiqué dans les films minces déposés sur du verre. A
partir de ces diagrammes de diffraction, on peut conclure que l'incorporation
de l'aluminium comme élément dopant n'affecte pas le
réseau de l'oxyde de zinc ZnO.
Les raies de diffraction les plus intenses
(2è~34°) des spectres DRX sont associées au plan (002), ce
qui dénote d'une forte orientation suivant l'axe c avec une structure
hexagonale wurtzite. Pour ZnO pur, le pic apparaît à 34.54°.
Pour les échantillons AZO dopés 3 et 5% atomique les pics se
positionnent à 34.58° et 34.50° respectivement.
Le pic relatif au film AZO3 est déplacé vers les
grandes valeurs de è, ce qui conduit à une diminution du
paramètre c. Cette diminution du paramètre de réseau est
directement liée a l'incorporation des ions Al+3 dans des
sites substitutionnels de Zn+2 [127, 129, 133]. L'incorporation du
dopant dans la matrice ZnO conduite donc à une contraction du
réseau.
Cependant, le pic (002) de la couche AZO5 est
déplacé vers les faibles valeurs de l'angle de diffraction, ce
qui correspond à une augmentation du paramètre c. Cette
augmentation du paramètre de réseau peut être
expliquée probablement par l'incorporation des ions Al+3 dans
les sites interstitiels au sein du réseau ZnO [134].
La diminution ou l'augmentation du paramètre c de la
maille peut également être liée aux effets des contraintes
qui ont pour la différence dans les du coefficients de dilatation
thermique du film á (ZnO) (7.10-6 °C-1) et du
substrat á (Si(100)) (2.6×10-6 °C-1).
Les valeurs déduite à partir de la DRX du
paramètre c de la maille, des films d'oxyde non dopé (ZnO) et
dopé Al (AZO) varient entre 0.5188 et 0.5199 nm. Le tableau III.2
regroupé, en plus de ces valeurs, les données relatives à
la taille des grains, les contraintes et les angles de diffraction de la raie
(002) des mêmes échantillons.
En se référant aux résultats de
l'étude obtenus pour les échantillons formés du film sur
du verre et présentés précédemment, il ressort que,
même dans le cas du substrat de silicium monocristallin Si(100), le
dopage en aluminium (AZO) altère la qualité cristalline des films
et abaisse la taille des grains des cristallites. Les valeurs calculées
de cette dernière décroissent de 38 à 26 nm quand on passa
de l'oxyde de zinc pur (ZnO) à l'oxyde dopé 5 %at. Al (AZO5).
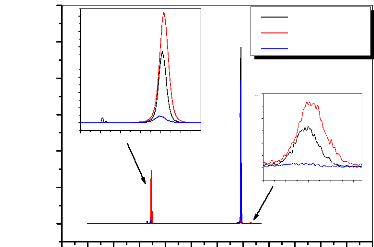
Intensite (u.a)
40000
60000
50000
30000
20000
10000
0
14000
12000
10000
4000
8000
6000
2000
0
32,5 33,0 33,5 34,0 34,5 35,0 35,5
Si(200)
(002)
Si(400)
(004)
300
200
100
0
72,0 72,4 72,8 73,2 73,6
ZnO/Si(100) AZO3/Si(100) AZO5/Si(100)
0 10 20 30 40 50 60 70 80 90 100 110 120
2è
Figure III.5. Spectres de diffraction des rayons X
(è-2è) des couches minces ZnO et AZO déposés
su
un substrat Si(100).
Tableau III.2. Variation des paramètres de
réseau des films minces ZnO et AZO déposés sur un substrat
Si(100)
|
couches
|
2è (°)
|
Taille des
grains (nm)
|
Distance inter
réticulaire (nm)
|
Contrainte (GPa)
|
Paramètre de la
maille c (nm)
|
|
ZnO
|
34.54
|
38
|
0.2597
|
+0.4920
|
0.5194
|
|
3 %at. Al: ZnO
|
34.58
|
32
|
0.2594
|
+0.7603
|
0.5188
|
|
5 %at. Al: ZnO
|
34.50
|
26
|
0.2600
|
+0.2684
|
0.5199
|
La variation de la taille des grains des films AZO
déposés sur Si(100) en fonction de la teneur du dopage en
aluminium est représentée sur la figure III.6. On remarque
à l'évidence que la taille des grains diminution avec le dopage
d'aluminium.
La couche mince non dopée ZnO est
caractérisée par des grains plus gros et elle présente une
meilleure cristallinité par rapport aux autres couches dopées
à l'aluminium.
Taille des grains (nm)
38
36
34
32
30
28
26



Figure III.6. Variation de la taille des grains des
couches minces ZnO et AZO déposée sur Si(100) en
fonction du
taux de dopage en aluminium.
La variation de la contrainte en fonction du dopage d'aluminium
est tracée sur la figure III.7.
Les valeurs des contraintes trouvées sont
situées entre (+0,2684) GPa et (+0,7603) GPa. La présence des
contraintes extensives est due principalement à l'insertion d'atomes
étrangers dans le réseau cristallin.

Contrainte (GPa)
0,8
0,7
0,6
0,5
0,4
0,3
0,2
Figure III.7. Variation des contraintes dans les
couches minces ZnO et AZO déposées sur Si(100) en
fonction du
taux du dopage en aluminium.
III.2.1.3. Substrat de silicium Si(111)
Les diffractogrammes des couches d'oxyde de zinc non
dopé ZnO et dopé aluminium (AZO) déposées sur des
substrats de Si(111) sont regroupés dans la figure III.8. Les deux pics
de diffraction enregistrés pour les angles de diffraction 34 et
72,8° correspondent aux plans (002) et (004) de la structure hexagonale
wurtzite ZnO. La raie la plus intense (28.4°) est caractéristique
des plans (111) du substrat Si(222). Les couches AZO présentent toujours
une croissance préférentielle suivant l'axe c. On remarque
également que l'intensité du pic (002) diminue quand le taux de
dopage d'aluminium croîts. A partir de ces diagrammes de diffraction nous
pouvons conclure que l'incorporation de l'aluminium comme élément
dopant n'affecte pas le réseau des films ZnO déposés sur
du verre ou sur silicium monocristallin Si(100) et Si(111).
Pour ZnO pur, le pic apparaît à 34.40°, alors
que pour les échantillons AZO dopés 3 et 5% at. Al, la même
raie se position à 34.41° et 34.60° respectivement.
Le pic (002) de film ZnO dopé déplacé
vers la forte valeur de è, ceci conduit à une diminution du
paramètre c, donc la distance inter réticulaire dans le film.
Cette diminution du paramètre de réseau est produite probablement
par l'incorporation des ions Al+3 dans les sites substitutionnels.
L'incorporation substitutionnel de l'ion Al+3 dans les sites de
Zn+2 lieu dans ces conditions de croissance. La substitution de
Zn+2 par Al+3 conduite à une contraction du
réseau.
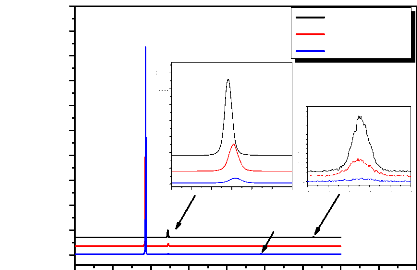
Intensite
450000
400000
350000
300000
250000
200000
500000
150000
100000
50000
0
Si(111)
21000
18000
15000
12000
9000
6000
3000
(002)
0
33,0 33,5 34,0 34,5 35,0 35,5 36,0
Si(222)
400
250
200
350
300
150
100
50
(004)
0
71,5 72,0 72,5 73,0 73,5 74,0
ZnO/Si(111) AZO3/Si(111) AZO5/Si(111)
10 20 30 40 50 60 70 80 90 100
2è(degrée)
Figure III.8. Spectres DRX de couches minces ZnO et AZO
déposés sur le substrat Si(111). Tableau III.3. Variation des
paramètres de réseau des films minces ZnO et AZO
déposées sur Si(100)
|
couche
|
2è (°)
|
Taille des
grains (nm)
|
Distance inter
réticulaire (nm)
|
Contrainte (GPa)
|
Paramètre de la
maille c (nm)
|
|
ZnO
|
34.40
|
40
|
0.2607
|
- 0.4025
|
0.5214
|
|
3 %at. Al: ZnO
|
34.41
|
38
|
0.2606
|
- 0.3578
|
0.5213
|
|
5 %at. Al: ZnO
|
34.60
|
25
|
0.2592
|
+ 0.8945
|
0.5184
|
Les valeurs du paramètre c varient pour cette série
d'échantillons, entre 0.5184 et 0.5214 nm (tableau III.3).
La taille des grains décroît de 40 à 25 nm
quand la concentration d'aluminium varie de 0 à 5% atomique.
La variation de la taille des grains en fonction du pourcentage
d'aluminium est représentée sur la figure III.9. On remarque que
la taille des grains diminution avec le dopage d'aluminium.
La couche mince ZnO non dopée est
caractérisée par une meilleure cristallinité par rapport
aux autres couches dopées à l'aluminium.
Taille des grains (nm)
38
36
34
32
30
28
26
24
42
40



Figure III.9. Variation de la taille des grains des
couches minces de ZnO et AZO déposées sur
Si(111) en fonction
du taux de dopage d'aluminium.
La variation de la contrainte en fonction du dopage d'aluminium
est montrée sur la figure III.9. Elle varie de (-0.425 GPa) à
(+0.8945 GPa).

Contrainte (GPa)
-0,2
-0,4
-0,6
-0,8
1,0
0,8
0,6
0,4
0,2
0,0
Figure III.10. Variation des contraintes dans les
couches minces ZnO et AZO déposées sur Si(111)
en fonction du
taux de dopage en aluminium.
III.2.1.4. Substrat de silicium polycristallin
(Si-poly).
L'étude des films d'oxyde de zinc sur Si-poly est
analogue aux études précédentes. En effet, la technique
DRX met en évidence la structure hexagonale wurtzite des films ZnO et
AZO avec une orientation peréféraitielle suivant l'axe
cristallographique C (figure III.11). Le décallage angulaire des raies
de diffraction est fonction de la teneur du dopage et est attribué
à des contraintes internes qui affectent le paramètre du
réseau c. Le tableau III.4 montre que la taille des grains diminue d'une
façon significative quand le dopage augmente (figure III.12), et que les
contraintes mécaniques qui apparaissent dans les films sont aussi
extensives que compressives (figure III.13).
Intensite
180
160
140
120
100
40
20
80
60
0

Si
(002)
ZnO/Si-Poly AZO3/Si-Poly AZO5/Si-Poly
10 20 30 40 50 60 70 80
2è (degrée)
Figure III.11. Spectres DRX de couches minces ZnO et
AZO déposées sur un substrat Si-poly.
Tableau
III.4. Variation des paramètres de réseau des films minces ZnO et
AZO déposés sur Si-poly.
|
Film
|
2è (°)
|
Taille des
grains (nm)
|
Distance inter
réticulaire (nm)
|
Contrainte (GPa)
|
Paramètre de la
maille c (nm)
|
|
ZnO
|
34.58
|
22
|
0.2594
|
+ 0.7603
|
0.5188
|
|
3 %at. Al: ZnO
|
34.54
|
17
|
0.2597
|
+ 0.4920
|
0.5194
|
|
5 %at. Al: ZnO
|
34.40
|
12
|
0.2607
|
- 0.4025
|
0.5214
|



22
20
18
16
14
Taille des grains (nm)
12
ZnO
0,8
0,6
Contrainte (GPa)
0,4
0,2
0,0
-0,2
-0,4
Figure III.12 : Variation de la taille des grains des
couches minces ZnO et AZO déposées sur Si-poly
pour
différents taux de dopage en aluminium.



ZnO
Figure III.13. Variation des contraintes dans les
couches minces ZnO et AZO déposées sur Si-poly
en fonction du
taux de dopage en aluminium déposées sur substrat de
Si-Poly.
De cette partie de l'étude, il ressort que la nature
des substrats utilisés influent sur la microstructure des couches minces
d'oxyde de zinc dopé Al ou non dopé (voir figure III.14 et
tableau III.5). En effet, les résultats expérimentaux montrent
que la cristallinité la plus faible des films (faible valeur de la
taille des grains), est obtenue pour des substrats de silicium
polycristallin. La décroissance de la taille des
cristallites avec la teneur Al est importante dans le cas du verre. La
meilleure cristallinité est obtenue pour des substrats de Si
monocristallin pour les quels la diminution de la taille des grains devient
notable pour les valeurs élevées du taux de dopage. La figure
III.15 montre la variation de la taille des grains en fonction de la nature des
substrats utilisés.
Quant aux contraintes internes, elles sont compressives dans le
cas du verre et elles sont extensives pour des substrats Si(100)
indépendamment de la teneur du Al.
Par contre, elles peuvent être aussi lien compressives
qu'extensives pour Si(100) et Si-poly. Un exemple de variation de la contrainte
en fonction du substrat est donné sur la figure III.16.
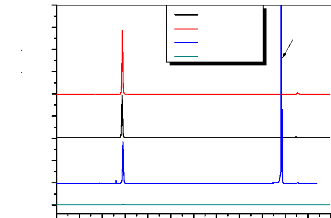
Intensite
45000
40000
25000
20000
35000
30000
15000
10000
5000
0
Si(200)
(002)
ZnO/Verre ZnO/Si(111) ZnO/Si(100)
ZnO/Si-Poly
Si(400)
(004)
20 25 30 35 40 45 50 55 60 65 70 75 80
2è (degrée)
Figure III.14. Spectres de DRX d'une couche mince ZnO
déposée sur différents substrats.
Tableau III.5. Variation des paramètres de
réseau d'une couche mince ZnO déposée sur
différents substrats.
|
Echantillon
|
2è (°)
|
Taille des
grains (nm)
|
Distance inter
réticulaire (nm)
|
Contrainte (GPa)
|
Paramètre de la
maille c (nm)
|
|
ZnO/verre
|
34.36
|
37
|
0.2610
|
- 0.6709
|
0.5220
|
|
ZnO/Si(111)
|
34.40
|
40
|
0.2607
|
- 0.4025
|
0.5214
|
|
ZnO/Si(100)
|
34.54
|
38
|
0.2597
|
+ 0.4920
|
0.5194
|
|
ZnO/Si-Poly
|
34.58
|
22
|
0.2594
|
+ 0.7603
|
0.5188
|
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|

Taille des grains (nm)
38
36
34
32
30
28
26
24
22
20
42
40
Substrats
Figure III.15. Variation de la taile des grains d'une
couche mince de ZnO déposée sur
différents
substrats.

Contrainte (GPa)
-0,2
-0,4
-0,6
-0,8
0,8
0,6
0,4
0,2
0,0
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|
Substrats
Figure III.16. Variation des contraintes dans les
couches minces ZnO déposées sur
différents
substrats.
Pour mieux illustrer les effets du
taux de dopage Al sur le réseau cristallin des films AZO3 et
AZO5 on
a tracé, en fonction de la nature des substrats, les spectres DRX
(figures III.17-18) les
variations de la taille des grains (figure
III.19-20) et de la contrainte mécaniques internes (figure
III.
21-22). Il s'avère que la meilleure cristallinité des couches est
obtenue sur des substrats de
Si(111). Aussi l'étude structurale
montre que les contraintes qui s'exercent à l'intérieur des
films
dépendent énormément et en même
temps de la nature des substrats et du taux de dopage en aluminium. Dans le cas
des dépôts de ZnO sur des substrats en verre, les contraintes
développées semblent être indépendantes du taux
atomique de l'aluminium.
Enfin, il est opportun de signaler que les
propriétés structurales des films formés par ablation
laser peuvent être tributaires des conditions expérimentales de
croissance des couches qui ne sont pas, en général,
reproductibles (chauffage des substrats, vitesse de déposition,
focalisation du faisceau laser, distance cible-substrat, et autre).
Intensite
40000
35000
30000
25000
20000
15000
10000
5000
0
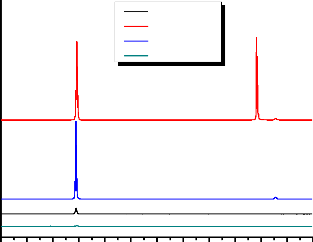
(002)
AZO3/Verre AZO3/Si(100) AZO3/Si(111)
AZO3/Si-Poly
Si(400)
(004)
20 25 30 35 40 45 50 55 60 65 70 75 80
2è (degrée)
Figure III.17. Spectres DRX d'une couche mince AZO3
déposée sur différents substrats.
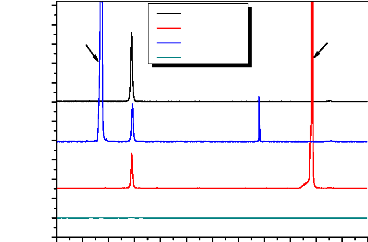
Intensite
4500
4000
2500
2000
5500
5000
3500
3000
1500
1000
-500
500
0
Si(111)
(002)
AZ5/Verre AZ5/Si(100) AZ5/Si(111)
AZ5/Si-Poly
Si(222)
(004)
Si(400)
20 25 30 35 40 45 50 55 60 65 70 75 80
2è (degrée)
Figure III.18. Spectres DRX d'une couche mince AZO5
déposée sur différents substrats.

Taille des grains (nm)
35
30
25
20
40
15
Si(111) Si(100) Verre Si-Poly
Substrats
Figure III.19. Variation de la taille des grains d'une
couche mince AZO3 déposée sur
différents
substrats.
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|

Taille des grains (nm)
28
26
24
22
20
18
16
14
12
10
Substrats
Figure III.20. Variation de la taille des grains d'une
couche mince AZO5 déposée sur
différents
substrats.

Contrainte (GPa)
-0,2
-0,4
0,8
0,6
0,4
0,2
0,0
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|
Substrats
Figure III.21. Variation des contraintes d'une couche
mince AZO3 déposée sur différents substrats.
Contrainte (GPa)
-0,2
-0,4
-0,6
1,0
0,8
0,6
0,4
0,2
0,0




Si(111) Si(100) Substrats Verre Si-Poly
Figure III.22. Variation des contraintes dans une
couche mince AZO5 déposée sur
différents
substrats.
III.3. Analyse par AFM
En général, la rugosité de surface est un
paramètre physique important dont l'influence sur certaines
propriétés, notamment optique, peut être non
négligeable. C'est pourquoi, on a jugé nécessaire et
intéressant d'analyser l'état de surface des films ZnO et AZO
fabriqués par la technique PLD dans le cadre de ce travail. Pour cela,
on a utilisé un microscope à force atomique AFM.
III.3.1.Effet de dopage
La figure III.23 montre des images AFM en 2D et 3D dimensions
des couches d'oxyde ZnO et AZO déposées sur des substrats en
verre. La rugosité Ra de surface des différents
échantillons a été calculée à partir des
images AFM en utilisant le logiciel "NanoRule" et les valeurs obtenues sont
présentées dans le tableau III.8. Ces valeurs montrent que la
rugosité Ra des couches ZnO est plus faible pour les films minces
dopés AZO. Autrement dit, la surface de la couche ZnO pur est plus
rugueuse que la surface des films dopés AZO. Ce résultat est de
grande importance vu que les morphologies de surface ont une application
potentielle dans l'amélioration du piégeage de la lumière
et particulièrement dans le domaine photovoltaïque.
Tableau III.8. Valeurs de la
rugosité de surface des couches ZnO et AZO déposées sur
des substrats verre.
|
Matériau
|
Rugosité de surface Ra (nm)
|
|
ZnO
|
15.61
|
|
AZO3
|
5.29
|
|
AZO5
|
10.74
|
La figure III.24 présente des images AFM des couches ZnO
et AZO déposées sur des substrats de Si(100).
Les valeurs obtenues de la rugosité de surface des
différents échantillons on été calculées
à partir des images AFM et elles sont regroupées dans le tableau
III.9.
Contrairement au cas précédent des
échantillons préparés sur du verre, la couche est plus
rugueuse sur le substrat Si(100). De plus, morphologie des couches montre des
structures denses et compactes, ce qui les rend en pratique très
efficaces dans le piégeage de la lumière dans les cellules
solaires en couches minces à base de silicium.
Tableau III.9. Valeurs de la
rugosité de surface des couches ZnO et AZO déposées sur
des substrats Si(100).
|
Matériau
|
Rugosité de surface Ra (nm)
|
|
ZnO
|
6.45
|
|
AZO3
|
11.55
|
|
AZO5
|
3.10
|
Par contre, dans le cas du substrat Si(111), les
résultats des observations AFM (figure III.25, tableau III.10) montrent
une rugosité de surface d'une valeur moyenne indépendamment du
dopage en aluminium et une structure relativement moins dense.
La figure III.26 illustre les images 2D et 3D AFM de surface
des films ZnO et AZO déposés sur des substrats de silicium
polycristallin et les valeurs correspondantes de la rugosité sont
mentionnées dans le tableau III.11. Il est intéressant de
constater dans ce cas que le dopage induit une rugosité de surface
très importante pouvant atteindre environ 70 nm dans
l'échantillon AZO3. La structure est plus ou moins compact avec des
grains de forme pyramidale.
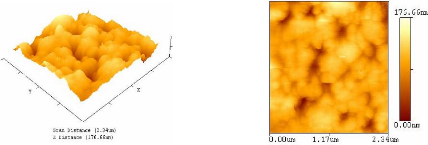
(a)
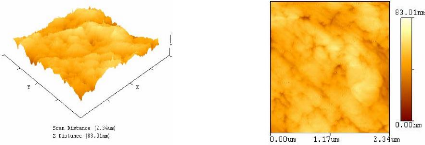
(b)
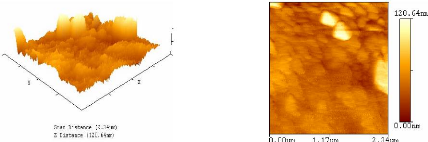
(c)
Figure III.23. Images 2D et 3D AFM des couches
minces ZnO et AZO déposées sur du verre:
ZnO pur (a), AZO3
(b), AZO5 (c) enduisant plus de 2.34 ìm X 2.34
ìm.

(a)
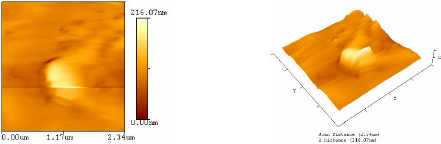
(b)

(c)
Figure III.24. Images 2D et 3D AFM des couches
minces ZnO et AZO déposées sur Si(100):
ZnO pur (a), AZO3 (b),
AZO5 (c) enduisant plus de 2.34 ìm X 2.34 ìm.

(a)

(b)

(c)
Figure III.25. Images 2D et 3D AFM des couches
minces ZnO et AZO déposées sur Si(111):
ZnO pur (a), AZO3 (b),
AZO5 (c) enduisant plus de 2.34 ìm X 2.34 ìm.

(a)

(b)

(c)
Figure III.26. Images 2D et 3D AFM des couches
minces ZnO et AZO déposées sur Si-poly:
ZnO pur (a), AZO3 (b),
AZO5 (c) enduisant plus de 2.34 ìm X 2.34 ìm.
Tableau III.10. Valeurs de la
rugosité de surface des couches ZnO et AZO déposées sur
des substrats Si(111).
|
Matériau
|
Rugosité de surface Ra (nm)
|
|
ZnO
|
9.36
|
|
AZO3
|
5.95
|
|
AZO5
|
8.78
|
Tableau III.11. Valeurs de la
rugosité de surface des couches ZnO et AZO déposées sur
des substrats Si-poly.
|
Matériau
|
Rugosité de surface Ra (nm)
|
|
ZnO
|
7.05
|
|
AZO3
|
67.66
|
|
AZO5
|
22.83
|
III.3.2.Effet des substrats
Pour mieux mettre en évidence l'influence de la nature
des substrats employés sur l'état de surface des films d'oxyde de
zinc déposés, on a schématisé l'évolution de
la rugosité avec les différences types de substrat et pour
différents taux de dopage.
Si on fait abstraction aux conditions expérimentales
qui varient sensiblement d'un dépôt à un autre, on
s'aperçoit que la surface la plus lisse est obtenue sur Si(100). Alors
que le dopage en aluminium fait augmenter la rugosité d'une façon
significative pour les films déposés sur des substrats de
silicium polycristallin.




|
Rugosite (nm)
|
16 14 12 10 8 6
|
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|
Substrats
(a)

Rugosite (nm)
70
60
50
40
30
20
10
0
|
Si(111)
|
Si(100)
|
Verre
|
Si-Poly
|
Substrats
(b)
Rugosite (nm)
|
25 20 15 10 5 0
|
|




Si(111)
Substrats
(c)
Figure III.27. Evolution de la rugosité Ra des
films minces ZnO (a) et AZO (b,c) en fonction
des substrats.
III.4. Caractérisation optique.
Comme il a déjà été indiqué
dans le premier chapitre I, l'oxyde de zinc présente des
propriétés optiques intéressantes en raison de ses
nombreuses applications technologiques. On rappelle que les principales
grandeurs optiques sont le coefficient d'absorption, le gap optique et l'indice
de réfraction. L'étude porte sur les couches
déposées sur des substrats de verre en considérant
l'influence du dopage en aluminium. La transmission optique dans le domaine
spectral UV-visible constitue une caractéristique importante permettant
d'évaluer la qualité des couches déposées. Elle
doit être maximale dans le visible.
Tous les films ont montré une transmission moyenne de
75% dans la région visible du spectre (figure III.30). Un
déplacement vers le bleu est remarquable à la limite d'absorption
de ZnO avec l'augmentation du taux de dopage en aluminium dans les films, ce
qui même à un accroissement de la largeur de la fenêtre de
transmission optique.
Transmittance (%)
100
90
40
20
80
70
60
50
30
10
0
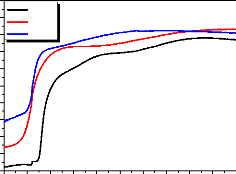
ZnO AZO3 AZO5
300 350 400 450 500 550 600 650 700 750 800
Longueur d'onde (nm)
Figure III.30. Spectres de transmission
optique des films ZnO et AZO déposées sur du verre.
Bien que l'allure générale des spectres soit
identique, ceux-ci sont composés de deux régions:
> Une région de forte transparence située
entre 400 et 800 nm, la valeur de la transmission est de l'ordre de 70 à
83% suivant le type d'échantillon. Cette valeur, rapportée par
plusieurs auteurs [135], confère aux couches minces ZnO et AZO, le
caractère de transparence dans le visible.
> Une région de forte absorption correspond à
l'absorption fondamentale (ë<400 nm) dans les films. Cette absorption
est due à la transition électronique inter bande. La variation
de
la transmission dans cette région est exploitée
pour la détermination du gap. D'autre part, on observe, avec
l'augmentation de pourcentage du dopage Al, un décalage du seuil
d'absorption vers les grandes énergies. Ce décalage est dû
à l'accroissement de la concentration des porteurs libres dans le
matériau [136]. Le décalage dans le seuil d'absorption est aussi
égal à la variation du gap ÄEg, exprimée
par la relation suivante [137]:
Ä
E
g = *
8 m
h
2 2
(
3
nð

)
3
où h, m* et n sont
respectivement la constante de Planck, la masse effective et la concentration
des électrons libres.
Cette relation montre que la variation du gap est due
principalement à la concentration des électrons libres. Par
conséquent, les films préparés avec différents
pourcentage du dopage aluminium renferment une concentration
élevée d'électrons libres [138].
A partir du spectre de transmission d'une couche, on peut
calculer le coefficient d'absorption et le gap optique du matériau qui
la constitue en utilisant les deux relations citées au paragraphe
II.4.4.3 du chapitre II.
A partir des représentations graphiques utilisant les
valeurs du gap optique déduites à partir des courbes de la figure
III.31, les énergies de bande interdite déterminées
à partir des spectres de transmission pour les couches minces
déposées sur de verre sont 3.23 pour ZnO et 3.36 eV pour les
couches ZnO dopé à aluminium (3 et 5 %at). Les valeurs obtenues
sont proches de la valeur rapportée sur ZnO pur (3.37 eV) [139]. Quand
le dopage Al croît, la variation est attribuée au décalage
de Burstein-Mouss [129,140]. Le gap des films augmente avec l'ajout d'aluminium
[141, 139].
De plus, il a été rapporté dans la
littérature que des films plus épais admettent toujours des
valeurs de gap plus faibles comparées aux couches plus minces [142].
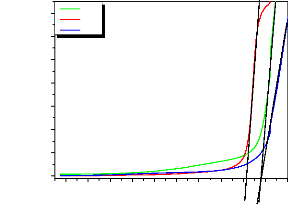
7,0x10-4
6,0x10-4
AZ5
ZnO
AZ3
1,0x10-4
0,0
1,6 1,8 2,0 2,2 2,4 2,6 2,8 3,0 3,2 3,4 3,6
hõ(eV)
(ahu)2 (1010cm-2ev2)
5,0x10-4
4,0x10-4
3,0x10-4
2,0x10-4
Figure III.31. Courbe (áhõ)2 en
fonction de hõ pour des films ZnO et AZO sur du verre.
Les indices de réfraction des films minces ZnO et AZO
et déposés par la technique de l'ablation laser sur du verre sont
calculés à partir des valeurs du gap optique et ils sont
donnés sur le tableau III.12. L'indice de réfraction diminue avec
la concentration du dopage d'aluminium et varie de 2,34 pour ZnO pur à
2,31 pour AZO. Ces données sont en général en bon accord
avec de la littérature [143].
Tableau III.12. Indices de réfraction des films
minces ZnO et AZO déposés sur des substrats du verre.
|
Couche mince
|
ZnO/Verre
|
AZO3/Verre
|
AZO5/Verre
|
|
Indice de réfraction
|
2.34
|
2.31
|
2.31
|
Conclusion Générale
Conclusion Générale
Ce mémoire de magister a porté sur la croissance
et les caractérisations de films minces d'oxyde de Zinc non dopés
(ZnO) et dopés en aluminium (AZO). Les couches minces ZnO et AZO ont
été déposées par ablation laser pulsé (PLD)
sur des substrats de verre et Si chouffés à 450°C. Cette
technique (PLD) à permis la croissance de films bien orientés
avec un très bon contrôle des éléments
déposés.
Cette étude est scindée en deux étapes.
La première étape de l'étude à porté sur
l'effet de dopage et la deuxième étape a concerné la
déposition de films sur différents substrats.
Les spectres obtenus par la méthode RBS permettent de
déterminer l'épaisseur et la proportion d'oxygène et de
zinc et renseigne sur le dopage en aluminium. Les spectres simulés
montrent la présence des couches ZnO d'épaisseurs 120- 370 nm
avec une distribution homogène de la concentration en aluminium dans les
films dopés.
Les couches minces de ZnO présentent
généralement une structure hexagonale de type wurtzite. Deux pics
de diffraction ont été enregistrés pour des angles de
diffraction 2è égaux à 34 et 72° et qui correspondent
aux pics (002) et (004) de la structure hexagonale wurtzite. Les couches AZO
présentent une croissance préférentielle suivant l'axe c.
De plus, aucun pic relatif à Al ou Al2O3 n'a
été observé. L'analyse par DRX indique que les couches
minces ZnO et AZO déposées ont une structure cristalline de haute
qualité avec une orientation préférentielle suivant l'axe
c.
Les pics de DRX pour certains échantillons se
déplacent vers les fortes valeurs de è d'antant plus que la
teneur du dopant Al augmente. Ceci conduit à une diminution du
paramètre c, donc, la distance inter réticulaire, qui est
égale à c/2 pour le plan (002) dans la structure hexagonal
wurtzite. Les valeurs du paramètre c de la maille, déduites des
spectres de la DRX, varient entre 0.5184 et 0.5220 nm. Cette diminution du
paramètre de réseau est produite probablement par l'incorporation
des ions AL+3 dans les sites substitutionnels.
Les pics de DRX dans autres échantillons se
déplacent vers les faibles valeurs de è, ce qui correspond
à une augmentation du paramètre c. Cette augmentation du
paramètre de réseau est produite probablement par l'incorporation
des ions Al+3 dans les sites interstitiels. La substitution de
Zn+2 par Al+3 ne conduite pas à une dilatation du
réseau.
La taille des grains est calculée en utilisant la formule
de Debye- Scherrer. Elle décroît, d'environ 12 à 40 nm
quand la concentration du aluminium varie de 0 à 5% atomique.
La couche mince non dopée déposée sur un
substrat Si(111) présente la taille des grains la plus grande, ce qui
atteste d'une meilleure cristallinité par rapport aux autres couches
dopées en aluminium.
D'une manière générale, le dopage de film
et la présence des impuretés sont des moyens très
efficaces pour augmenter ou réduire les contraintes internes des
matériaux élaborés sous forme de couches minces. Les
contraintes dans les films ZnO ont été estimées à
partir de l'exploitation du décalage de la position du pic (002) des
spectres de diffraction X par rapport à è= 34°. Les valeurs
des contraintes trouvées dans les couches sont situées entre (-
0,6709) et (+ 0,8945) GPa. La présence des contraintes extensives est
probablement due à substitution d'atomes étrangers dans le
réseau cristallin.
L'étude par AFM de la morphologie de la surface des
échantillons ZnO dopé en aluminium sur les différents
substrats permet d'avoir une idée relative à l'effet de dopage en
aluminium et de la nature des substrats sur la rugosité surfacique des
films. Les valeurs de la rugosité de surface des couches ZnO
déposées sur les substrats de verre, de silicium polycristallin
et monocristallin varient entre 3.10 et 67.66 nm.
Tous les films ont montré une transmission moyenne de
75% dans la région visible, Un déplacement vers le bleu est
remarquable à la limite d'absorption de ZnO avec l'augmentation de la
concentration d'aluminium dans les films, car elle même à un
accroissement de la largeur de la fenêtre de transmission.
Les énergies de bande interdites
déterminées à partir des spectres pour les couches minces
déposées sur de verre obtenus sont 3.23 pour film de ZnO et 3.36
eV pour les couches ZnO dopé à aluminium. L'indice de
réfraction diminue avec la concentration du dopage d'aluminium et varie
de 2,34 pour ZnO jusqu'à 2,31 pour AZO.
Les couches AZO synthétisées présentent
une forte transparence et une surface plus ou moins rugueuse, ce qui les rend
très adaptées pour une application de contact de surface dans les
cellules solaires en couches minces.
Références bibliographiques
Références
bibliographiques
[1] D.P., Norton ; Y.W., Heo ; M.P., Ivill ; K., Ip ; S.J.,
Pearton ; M.F., Chisholm ; T., Steiner Mater. Today 7 (2004) 34.
[2] J. Joussot-Dubien, Nouveau Traité de Chimie
Minérale, Vol. 5, Masson & Cie, Paris (1962)
[3] A.F. Kohn, G. Ceder, D. Morgon, C.G. Van de Walle, Phys.
Rev.B, 61 (2000) 15019.
[4] B. J. Lokhand, M. D. Uplane, App. Surf. Sci. 167 (2000)
243-246.
[5] Van Heerden, P. Bhattacharya, R.S. Katiyar, Materials
Science and Engineering B103 (2003) 9-15.
[6] A. Bougrine, A. El Hichou, M. Addou, J. Ebothé, A.
Kachouna, M. Troyon, Material Chemistry and Physics 80 (2003) 438-445.
[7] I. Vurgaftman and J. R. Meyer. Band parameters for
nitrogen-containing semiconductors. J. Appl. Phys, 94 (2003) 3675
[8] S. L. Chuang and C. S. Chang. k.p method for strained
wurtzite semiconductors. Phys. Rev. B, 54 (1996) 2491
[9] W. R.L. Lambrecht, A. V. Rodina, S. Limpijumnong, B. Segall,
and B. K. Meyer. Valence- band ordering and magneto-optic exciton _ne structure
in ZnO. Phys. Rev. B, 65 (2002) 075207
[10] G. Bastard. Wave mechanics applied to semiconductor
heterostructures. Les editions de physique, (1992).
[11] D. G. Thomas. The exciton spectrum of zinc oxide. J. Phys.
Chem. Solids, 15 (1960) 86
[12] D. C. Reynolds, D. C. Look, B. Jogai, C. W. Litton, G.
Cantwell, and W. C. Harsch. Valence-band ordering in ZnO. Phys. Rev. B, 60
(1999) 2340
[13] B. Gil, A. Lusson, V. Sallet, S. A. Said-Hassani, R.
Triboulet, and P. Bigenwald. Strain- feelds elects and reversal of the nature
of the fundamental valence band of ZnO epilayers. Jpn. J. Appl. Phys., 40
(2001) 1089.
[14] C. Klingshirn. ZnO : from basics towards applications.
Phys. Stat. Sol. (b), 244 (2007) 3027
[15] A. Ashra_ and C. Jagadish. Review of zincblende ZnO :
stability of metastable ZnO phase. J. Appl. Phys., 102 (2007) 071101
[16] I. Vurgaftman and J. R. Meyer. Band parameters for III-V
compound semiconductors and their alloys. J. Appl. Phys., 89 (2001) 5815
[17] http ://www.io_e.ru/SVA/NSM/Semicond/.
[18] Landolt-Börnstein. Numerical data and functional
relationship in science and technology, Vol. III/17a et Vol. III/17b. Springer,
Berlin (1982).
[19] C. F. Klingshirn. Semiconductor Optics, volume 45. Springer
(1997).
[20] A. Mosbah, << élaboration et caracterisation
de couches mince d'oxyde de zinc », Thèse doctorat de Univ.
Mentouri Constantine » (2009).
[21] Handbook of Chemistry and Physics, 56th Edition, Ed. R.C.
Weast, CRS Press, (1975)
[22] E.M. Bachari, G. Baud, S. Ben Amor, M. Jacquet, Thin Solid
Films, 165 (1999) 348
[23] T.K. Subramanyam, B. Srinivasulu Naidu, S. Uthanna, Cryst.
Res. Technol, 35 (2000) 193
[24] M. Rebien, W. Henrion, M. Bär, C.H. Fischer, App.
Phys. Lett, 80 (2002) 3518
[25] F. Ng-Cheng-Chin, M. Roslin, Z.H. Gu. T.Z. Fahidy, J. Phys.
D: Appl. Phys., 31 (1998) 71
[26] D. Vaufrey, << Optimisation de structures ITO /
semiconducteurs organiques », Thèse de doctorat de l'ecole centrale
de lyon» (2003).
[27] W. Li, D. Mao, F. Zhang, X. Wang, X. Liu, S. Zou, Q. Li and
J. Xu, Nucl. Instrum. Methods. Phys. Res. B169 (2000) 59.
[28] Özgür Ü ; Y.I. Alivov ; C. Liu ; A. Teke ;
M.A. Reshchikov ; M.A. Dogan ; V. Avrutin ; S.J. Cho ; H. Morkoc J. Appl. Phys
98 (2005) 041301_1.
[29] J.P. Monsier ; S. Chakrabarti ; B. Doggett ; E. McGlynn ;
M.O. Henry ; A. Meaney Pro. SPIE. 2007, 6474, 64740I.
V. Srikant, D.R. Clarke, J. App. Phys., 83 (1998) 5447
[30] K.I. Chopra, S. Major and D.K. Pandya, Thin solid _lms 1
(1986) 102
[31] T. Aoki, Y. Shimizu, A. Miyake, A. Nakamura, Y. Nakanishi,
Y. Hatanaka, p-Type ZnO Layer Formation by Excimer Laser Doping, physica status
solidi b, , 911 (2001) 229- 232
[32] A.F. Kohn, G. Ceder, D. Morgon, C. G. Van de Walle, Phys.
Rev.B, 61 (2000) 15019.
[33] K. Tominaga, T. Murayama, I. Mori, T. Ushiro, T. Moriga, I.
Nakabayashi, Thin Solid Films, 386 (2001) 267.
[35] T.L.Chu, S.S.Chu, Solid-State Electronics, 38 (1995)
533.
[36] De la torre Y Ramos J. Thèse de doctorat, Institut
national des sciences appliquées de Lyon, (2003).
[37] F-Josef Haug, Thesis of doctorat, Swiss Federal Institute
of technologie Zurich (2001).
[38] J. Nishino, Shigeo Ohshio, and Kiichiro Kamata, J. Am.
Ceram. Soc, 75 (1992). 3469-72.
[39] I. Wuled Lengooro, Yun Chan Kang, Takafumi Komiya, Kikuo
Okuyama and Noboru Tohge, Jpn. J. Appl. Phys.(1998) 288-290.
[40] C. Mazon, J. Muci, A. Sa-Neto, A. Ortiz-Conde and F.J.
Garcia, CH2953-8/91/10000-1156. IEEE (1991).
[41] E. Fortunato, N. Correia, and P. Barquinha, C. Costa, L.
Pereira, G. Gonçalves, R. Martins. Paper field effect transistor. in
Proc. SPIE, 7217 (2009) 72170K
[42] A. Zylbersztejn and N.F. Mott, Metal-insulator transition
in vanadium dioxide, Physical Review B, 11(1975) 4383-4395.
[43] Y. Paz, Z. Luo, L. Rabenberg, A. Heller, Photooxidative
self-cleaning transparent titanium dioxide films on glass, Journal of Materials
Research, 10(1995) 2842-2848.
[44] A. Zaleska, E. Grabowska, J.W. Sobczak, M. Gazda, J. Hupka,
Photocatalytic activity of boron-modified TiO2 under visible light: The effect
of boron content, calcination temperature and TiO2 matrix, Applied Catalysis B:
Environmental, 89(2009) 469-475.
[45] B. Liu, X. Wang, G. Cai, L. Wen, Y. Song and X. Zhao, Low
temperature fabrication of V- doped TiO2 nanoparticles, structure and
photocatalytic studies, Journal of Hazardous Materials, 169(1-3) (2009)
1112-1118.
[46] T. Minami, New n-type transparent conducting oxides, MRS
Bulletin 25/8 (2000) 38.
[47] M.A. Marquardt, N.A. Ashmore, and D.P. Cann, Crystal
chemistry and electrical properties of the delafossite structure, Thin Solid
Films, 496(1) (2006) 146-156.
[48] D.S. Ghosh, et al., Widely transparent electrodes based on
ultrathin metals, Optics Letters, 34(3) ( 2009) 325-327.
[49] S.-I. Na, S.S. Kim, J. Jang, D.-Y. Kim, Efficient and
flexible ITO-free organic solar cells using highly conductive polymer anodes,
Advanced Materials, 20(21) (2008) 4061-4067.
[50] S. Parthiban, V. Gokulakrishnan, K. Ramamurthi, E.
Elangovan, R. Martins, E. Fortunato, and R. Ganesan, High near-infrared
transparent molybdenum-doped indium oxide thin films for nanocrystalline
silicon solar cell applications, Solar Energy Materials and Solar
Cells, 93(1) (2009) 92-97.
[51] M.F.A.M. Van Hest, M.S. Dabney, J.D. Perkins, D.S. Ginley,
and M.P. Taylor, Titanium- doped indium oxide: A high-mobility transparent
conductor, Applied Physics Letters, 87(3) (2005) 1-3.
[52] R. Bel Hadj Tahar, T. Ban, Y. Ohya, and Y. Takahashi, Tin
doped indium oxide thin films: Electrical properties, Journal of Applied
Physics, 83(5) (1998) 2631-2645.
[53] K.H. Kim, K.C. Park, and D.Y. Ma, Structural, electrical
and optical properties of aluminum doped zinc oxide films prepared by radio
frequency magnetron sputtering, Journal of Applied Physics, 81(12) (1997)
7764-7772.
[54] V. Assunçao, E. Fortunato, A. Marques, H. A. Guas,
I. Ferreira, M.E.V. Costa, and R. Martins, Influence of the deposition pressure
on the properties of transparent and conductive ZnO:Ga thin-film produced by
r.f. sputtering at room temperature, Thin Solid Films, 427(1-2) (2003)
401-405.
[55] P. Nunes, E. Fortunato, P. Tonello, F.B. Fernandes, P.
Vilarinho, and R. Martins, Effect of different dopant elements on the
properties of ZnO thin films, Vacuum, 64(2002) 281- 285.
[56] C. Terrier, J.P. Chatelon, and J.A. Roger, Electrical and
optical properties of Sb:SnO2 thin films obtained by the sol-gel method, Thin
Solid Films, 295(1-2) (1997) 95-100.
[57] Y. Wang, T. Brezesinski, M. Antonietti, and B. Smarsly,
Ordered mesoporous Sb-, Nb-, and Ta-doped SnO2 thin films with adjustable
doping levels and high electrical conductivity, ACS Nano, 3(6), (2009)
1373-1378.
[58] G. Korotcenkov, S.D. Hana,, (Cu, Fe, Co, or Ni)-doped
tin dioxide films deposited by spray pyrolysis : Doping influence on thermal
stability of the film structure, Materials Chemistry and Physics, 113
(2009)756-763.
[59] M. Jiang, X. Liu, Structural, electrical and optical
properties of Al-Ti codoped ZnO (ZATO) thin films prepared by RF magnetron
sputtering, Applied Surface Science, 255 (2008) 3175-3178.
[60] A.E. Rakhshani, Y. Makdisi, and H.A. Ramazaniyan,
Electronic and optical properties of fluorine-doped tin oxide films, Journal of
Applied Physics, 83(2) (1998)1049-1057.
[61] B.N. Pawar, S.R. Jadkar, and M.G. Takwale, Deposition
and characterization of transparent and conductive sprayed ZnO:B thin films,
Journal of Physics and Chemistry of Solids, 66(10) (2005)1779-1782.
[62] A. Ortiz, C. Falcony, J.A. Hernandez, M. Garcia, and J.C.
Alonso, Photoluminescent characteristics of lithium-doped zinc oxide films
deposited by spray pyrolysis, Thin Solid Films, 293(1-2) (1997)103-107.
[63] S.B. Zhang, S.-H. Wei, and A. Zunger, Intrinsic n-type
versus p-type doping asymmetry and the defect physics of ZnO, Physical Review B
- Condensed Matter and Materials Physics, 63(7) (2001)0752051-0752057.
[64] T.M. Barnes, K. Olson, and C.A. Wolden, On the formation
and stability of p-type conductivity in nitrogen-doped zinc oxide, Applied
Physics Letters, 86(11) (2005)1-3.
[65] J.G. Lu, Z.Z. Ye, F. Zhuge, Y.J. Zeng, B.H. Zhao, L.P. Zhu,
p-type conduction in N-Al co-doped ZnO thin films, Appl. Phys. Lett, 85(15)
(2004)31-34.
[66] J. Ni, X. Zhao, X. Zheng, J. Zhao, and B. Liu,
Electrical, structural, photoluminescence and optical properties of p-type
conducting, antimony-doped SnO2 thin films, Acta Materialia, 57(1)
(2009)278-285.
[67] R. Nagarajan, N. Duan, M.K. Jayaraj, J. Li, K.A. Vanaja,
A. Yokochi, A. Draeseke, J. Tate, and A.W. Sleight, p-Type conductivity in the
delafossite structure, International Journal of Inorganic Materials, 3(3)
(2001)265-270.
[68] H. Kawazoe, M. Yasukawa, H. Hyodo, M. Kurita, H. Yanagi, H.
Hosono, P-type electrical conduction in transparent thin films of CuAlO2,
Nature, 389 (1997) 939-942.
[69] Ph. Lami et Y. Pauleau, J. Electrochem. Soc.: Solid-State
Science and Technology 135 (1988) 980.
[70] B. Grolleau, Le vide, les couches minces 204 (1980).
[71] T. Matsushima, thèse (Univ. d'Osaka, Japon, 1991) p.
49.
[72] McClanahan E.D., Laegreid N., «Sputtering by particle
bombardment III», Berlin: Springer Verlag, (1991). Chapter 7, Production
of thin films by controlled deposition of sputtered material, pp. 339.
[73] Maissel L., Glang R., «Handbook of thin film
technology». New York: McGraw-Hill, 1970.
[74] Bessot J.J., «Dépôts par
pulvérisation cathodique», Technique de l'Ingénieur, (1985),
Vol. M 7, Chap. 1657, pp. 1.
[75] T. Minami, S. Ida, T. Miyata, Y. Minamino, Thin Solid
Films, 445 (2003) 268.
[76] N. Nakamura, H. Nakagawa, K. Koshida, M. Niiya, Proceeding
of the 5th International Display workshops, (1998) 511.
[75] H. Koinuma, N. Kanda, J. Nishino, A. Ohtomo, H. Kuboto, M.
Kawasaki, M. Yoshimto. App. Surf. Sci, 514 (1997) 109-110.
[76] P. Fons, K. Iwata, A. Yamada, L. Matsubara, S. Niki, K.
Nakahara, T. Tanabe and H.
Takasu. App. Phys. Lett, 77 (2000) 1801.
[77] T. Miyata, S. Ida, T. Minami, J. Vac. Sci. Technol., A 21
(4) (2003) 1404
[78] J. Ma, F. Ji, D.H. Zhang, L.L. Ma, S.Y. Li, Thin Solid
Films, 357 (1999) 98.
[79] A.A. Dakhel, Mat. Chem. Phys, 81 (2003) 56.
[80] Douglas B.Chrisey and Graham K. Huubler, ½ Pulsed
Laser Deposition of Thin Film½ ed. Wiley interscience, New York (1994)
258.
[81] D. P. Norton, B. C. Chakoumakos, J. D. Budai, D. H.
Lowndes, B. C. Sales, J. R. Thompson, D. k. Christen, Science 265(5181) (1994)
2074-2077.
[82] P. Padhan, W. Prellier, and B. Mercey, Phys. Rev. B 70
(2004) 184419.
[83] X. Wang, S. Yang, J. Wang, M. Li, X. Jiang, G. Du, X. Liu,
R.P.H. Chang, J. Cryst. Growth, 226 (2001) 123.
[84] J. Ye, S. Gu, S. Zhu, T. Chen, L. Hu, F. Qin, R. Zhang, Y.
Shi, Y. Zheng, J. Cryst. Growth, 243 (2002) 151.
[85] B.J. Lokhande, P.S. Patil, M.D. Uplane, Mater.Lett, 57
(2002) 573.
[86] R. Ayouchi, F. Martin, D. Leinen, J.R. Ramos-Barrado J.
Cryst, Growth, 247 (2003) 497.
[87] J. W. Elam, Z.A. Sechrist, S.M. George, Thin Solid Films,
43 (2002) 414.
[88] E.B. Yousfi, J. Fouache, D. Lincot, Appl. Surf. Sci., 153
(2000) 223.
[89] K. Saito, Y. Watanabe, K. Takahashi, T. Matsuzawa, B. Sang,
M. Konaga Solar Energy Materials and Solar Cells., 49 (1997) 187-193.
[90] J. Lu, Z. Ye, J. H. huang, L. Wang, B. Zhao, Appl. Surf.
Sci., 207 (2003)
[91] S.J. Baik, J.H. Jong, C.H. Lee, W.Y. Cho, & K.S. Lim,
Appl. Phys. Lett., 70 (1997) 3516.
[92] Y.C. Wang, I.C. Leu, M.H. Hon, J. Appl. Phys., 95 (2004)
1444.
[93] J.L. Vossen et W.Kern, Thin film processes Ed.Academic
press 1978; traite de la pulvérisation en général avec une
liste de références très complète jusqu'à
1977.
[94] D. Bouchier, thèse (Orsay, 1985) p. 122.
[95] Chen Bao-qing La technologie de pulvérisation
cathodique (en chinois) (Editions Scientifiques du Ministère de
l'Industrie de Chine, 1990)
[96] Ph. Lami et Y.Pauleau J.Electrochem.Soc. : Solid-statae
science and technology
[97] I. Wuled Lengooro, Yun Chan Kang, Takafumi Komiya, Kikuo
Okuyama and Noboru Tohge, Jpn. J. Appl. Phys.(1998) L 288-L 290.
[98] C. Mazon, J. Muci, A. Sa-Neto, A. Ortiz-Conde and F.J.
Garcia, CH2953-8/91/10000 1156. IEEE (1991).
[99] S. Zerkout, Thèse de doctorat, Université de
Constantine.
[100] J. Hirunlabh, S. Suthateeranet, K. Kirtikara and Ralph D.
Pynn, Thammasat Int. J. Sc.Tech, 3 (1998) 2
[101] S. Zerkout, << Etude des propriétés
des couches de TiNx et TiN-Fe élaborées par pulvérisation
magnétron réactive >>, Thèse de doctorat,
Université de Constantine (2004).
G. K.Wehner, Phys.Rev, (1971) 690
[102] C. Pedoussat, << Modélisation
auto-cohérente de la pulvérisation cathodique dans les
décharges luminescentes basse pression >>, Thèse de
doctorat, Université Paul Sabatier- Toulouse, (1999).
[103] A. Zozime, C. Vermeulin, Revue phys. Appl. 23 (1988)
1825-1835
[104] De la Torre Y Ramos J, << Etudes des
propriétés opto-électroniques de structures et de
composants à base de nanostructures de Si >>, Thèse de
doctorat, Institut national des sciences appliquées de Lyon, (2003).
B. J. Lokhand, M. D. Uplane, App. Surf. Sci. 167 (2000)
243-246
[105] B. J. Lokhande, P.S. Patil, M.D, Uplane, Materials Letters
57 (2002) 573-579
[106] F-Josef Haug, <<High efficiency thin-film passivated
silicon solar cells and modules- THIFIC: Thin film on crystalline Si>>,
Thesis of doctorat, Swiss Federal Institute of technologie Zurich (2001).
[107] F. Ng-Cheng-Chin, M. Roslin, Z. H. Gu. T. Z. Fahidy,
J.Phys.D Appl.Phy;31(1998).
[108] J. Jacque Bessot, S. Audisio, Techniques de
l'ingénieur; traitement de surface M5,4 (1989), 1655-1660.
[109] L. A. Goodman, RCA Rev. 35(1974) 613.
[110] C. M. Lampert. Sol. Energy Mater. (1981) 6-11.
[111] K. T. Ramakrisha Reddy, T.B.S. Reddy, I. Forbes, R.W.
Miles, Surf. and Coat. Techn. 151-152 (2002) 110-113.
[114] G. Huertas « Etude de Nouveaux Matériaux
D'électrode Positive et d'électrolyte Solide Vitreux Sous Forme
de Couches minces pour des Couches Minces Microbatteries au Lithium »,
Thèse de doctorat, université de Bordeaux, (2006).
[115] R. Swanepoel, J. Phys. E 16 (1983) 1214
[116] N. F. Mott, E. A. Davis Electronic Process in
Non-crystalline Materials, Bristol, (1979)
[117] W. E. Spear et P. G. Le Comber, Solid St. Comm., 17 (1975)
1193
[118] J. Tauc, A. Menthe, J. Non-Cryst. Sol, 569 (1972) 8-10
F. Urbach, Phys. Rev, 92 (1953) 1324
[119] C.C. Chen, M.M. Nasrallah, and H.U. Anderson, J.
Electrochem. Soc., 12, 140, 3555 (2003).
[120] C.J. Brinker, G.C. Frye, A.J. Hurd, and C.S. Ashley, Thin
Solid Films, 1, 201, 97, (1991).
[121] N. Ekem, S. Korkmaz, S. Pat, M.Z. Balbag, E.N. Cetin, M.
Ozmumca, International Journal of Hydrogen Energy, 34, 5218-5222, (2009).
[122] En-Gang Fu, D-M. Zhuang, G. Zhang, Z. Ming, W-F. Yang and
J-J. Liu, Microelectronics Journal, 35, 383 (2004).
[123] F. K. Shan and Y. S. Yu, Journal of the European Ceramic
Society, 24,1869(2004)
[124] W. Tang and D.C. Cameron. Thin Solid Films,
238, 83(1994).
[125] Xu Zi-qiang. Deng Hong. Li Yan, Cheng Hang, Materials
Science in Semiconductor Processing 9,132-135 (2006).
[126] S.H. Jeong, B.N. Park, S.-B. Lee, J.-H. Boo, Surface &
Coatings Technology 201, 5318- 5322 (2007).
[127] C. Li, M. Furuta, T. Matsuda, T. Hiramatsu, H. Furuta, T.
Hirao, Thin Solid Films 517, 3265-3268 (2009).
[128] S. Venkatachalam, Y. Iida, Yoshinori Kanno, Superlattices
and Microstructures 44, 127- 135 (2008).
[129] R.K. Shukla, Anchal Srivastava, Atul Srivastava, K.C.
Dubey, Journal of Crystal Growth 294, 427-431 (2006).
[130] A. Neiderhofer, P. Nesladek, H.D. Männling, K. Moto,
S. Veprek and M. Jille, Surf. Coat. Technol, 173, 120-121 (1999).
[132] S.S. Kim and B. T. Lee, Thin Solid Films 446, 307
(2004).
[133] K.P. Bhuvana, J. Elanchezhiyan, N. Gopalakrishnan, T.
Balasubramanian, Applied Surface Science 255, 2026-2029 (2008).
[134] Qing Hua Li, Deliang Zhu, Wenjun Liu, Yi Liu, Xiao Cui Ma,
Applied Surface Science 254, 2922-2926 (2008).
[135] M. Rebien, W. Henrion, M. Bar, Ch-H.Fischer, Appl. Phys.
Lett ; 80, 18-35, (2002).
[136] L. A. Goodman, RCA Rev, 35, 613, (1974).
[137] J. Mass, P. Bhattacharya, R.S. Katiyar Materials Sciences
and Engineering B103, 9-15, (2003).
[138] I. Ozeroy, D. Nelson, A.V. Bulgakov, W. Marine, M. Sentis,
Applied Surface Science 212-213, 349-352, (2003).
[139] Xue-Yong Li, Hong-Jian Li, Zhi-Jun Wang, Hui Xia, Zhi-Yong
Xiong, Jun-Xi Wang,Bing- Chu Yang, Optics Communications 282, 247-252
(2009).
[140] Sang-Moo, Tomoaki Ikegami, Kenji Ebihara, Paik-Kyun Shin,
Applied Surface Science, 253, 1522-1527, (2006).
[141] Wei Lin, Ruixin Ma, Wei Shao, Bin Liu, Applied Surface
Science 253, 5179-5183 (2007).
[142] D. Bao, X. Yao, N. Wakiya, K. Shinozaki, N. Mizutani,
Appl. Phys. Lett. 79/3, 3767 (2001).
[143] Q H. Yashikawa and S. Adachi, Japonise Journal of Applied
Physics, 36, 6237 (1997).
Contribution in the study of structure and
microstructure of ZnO
films obtained by pulsed laser deposition
Abstract
In this work, we prepared undoped (ZnO) and aluminium doped
(AZO) thin films by pulser laser deposition (PLD) technique. Synthesized films
have been on glass and silicon substrates heated at 4500C. The used
source was a KrF eximer laser (248 nm, 25 ns, 2 J / cm2). Different
experimentales technique have been carried out to analyse the fabricated films;
the X-ray diffraction (XRD) for analysis of films structure; atomic force
microscopy (AFM) used to study morphology and surface roughens, Rutherford
backxattering spectroscopy for determination of the atomic composition and
thickness of films. The transmittance was of the order 75% in visible with an
optical band gap varying from 3.23 to 3.36 eV when the content of Al doping
increases from 0 to 5 at.%.
Keywords: thin films, ZnO, doping, PLD,XRD, AFM,
RBS.
|
ÉÞíÑØÈ
|
ÉÑÖÍãáÇßäÒáÇ
ÏíÓß ÉÍíÑÔá
ÉíæíäÈæÑßíãáÇ
æ ÉíæíäÈáÇ
ÉÓÇÑÏáÇ í
ÉãÇÓãáÇ
|
íÑÒíááÇ
áÇÕÆÊÓ~Ç
ÕÎáã
|
ÉÞíÑØÈ
ãæíäãáSÇÈ
áãÚÊÓãáÇ
ÚÇÚÔáÇ
íáíÖÊ æãä Úã
ÉíÓÇÏÓ ÇíØã
'åÊäæÔÎ Çã
ÑíÛÊí
ÚæäããáÇ
|
ÉãÚØã æ
ÉãÚØã ÑíÛ
ßäÒáÇ ÏíÓß
äã ÉÞíÞÑ
ÍÆÇÑÔ
ÑíÖÍÊÈ
ÉÑßÐãáÇ åÐ
ÑÇØÅ í ÇäãÞ
.450°C ÉÑÇÑÍ
ÉÌÑÏ í
ÇíÑÇÑÍ
ÉäÎÓãáÇ
ãæíÓáÓáÇ æ
ÌÇÌÒáÇ
ÏäÇÓã ìáÚ
ÇÚÖæÈ
íÑÒíááÇ
áÇÕÆÊÓ7Ç
í ZnO ÉÍíÑÔá
ÉíÑæáÈáÇ
ÉíäÈáÇ . (248 nm, 25 ns, 2
J/cm2) eximer KrF ÑÒíááÇ
æ æ ÍØÓáÇ
ÉíÌæáæÑæã
ÉÓÇÑÏá (AFM)
ÉíÑÐáÇ
ÉæÞáÇ ÑÌã
ÉØÓÇæÈ
ÇáíáÍÊ ãÊ æ .(002)
åÇÌÊ7Ç Þæ
ÞÇØäáÇ ÖÑÚÈ
íÆÑãáÇ
áÇÌãáÇ í 75%
ÉÈÊÑ äã
ÊÇäíÚáÇ
ÉíÇÔ .ßãÓáÇ
æ ÈíßÑÊáÇ
ÏíÏÍÊá
ÏÑÑæÑÏÑ
. ÇíÑÐ 5 % ìáÅ 0
äã ÏíÇÒÊáÇÈ
ÏíÇÒÊÊ
ãæíäãá~ÇÈ
ÉãÚØã
ÍÆÇÑÔáÇ
äæßÊ ÇãÏäÚ 3.36 eV
æ 3.23 äíÈ
|
|
:
|
É
íÍÇÊãáÇ
ÊÇãáßáÇ
|
. ÉíÑÐáÇ
ÉæÞáÇ ÑÌã ,
íÑÒíááÇ
áÇÕÆÊÓ~Ç ,
ãæíäãátÇÈ
ãÚØã ßäÒáÇ
ÏíÓß , ãÚØã
ÑíÛ ßäÒáÇ
ÏíÓß ,
ÉÞíÞÑáÇ
ÍÆÇÑÔáÇ
Contribution à l'étude structurale et
microstructurale de films ZnO
obtenus par ablation laser
Résumé
Dans ce travail de magister, nous avons préparé
des couches minces d'oxyde de zinc non dopées (ZnO) et dopées
à l'aluminium (AZO) par la technique de l'ablation laser pulsé
(PLD). Les films ont été déposés sur des substrats
de verre et de silicium chouffés à 450°C. La source
utilisée est un laser excimer KrF (248 nm, 25 ns, 2 J/cm2).
Les couche fabriquées ont éte sont analysées par plusieurs
techniques : la diffraction des rayons X (DRX) pour analyser la structure des
films, la microscopie à force atomique (AFM) pour l'étude de la
morphologie et de la rugosité des surfaces, la spectroscopie de
rétrodiffusion Rutherford (RBS) pour la détermination de la
stoechiométrie et de l'épaisseur, Et enfin la
spectrophotométrie UV-visible pour déterminer les
propriétés optiques des couches mince ZnO et AZO. La structure
des films déposés est hexagonale de type wurtzite avec une
orientation préférentielle suivant l'axe (002). La transmittance
est de l'ordre de 75 % dans le visible, et l'énergie de la bande optique
interdite varie de 3.23 à 3.36 eV quand le dopage en aluminium
croît de 0 à 5% at.
Mots clés : couche mince, ZnO dopage,
PLD, DRX, AFM, RBS.
| 


